반도체 공정은 웨이퍼를 제조하고 회로를 새기는 전공정, 칩을 패키징하는 후공정으로 나뉜다. 이중 후공정은 반도체 미세화 기술이 한계점에 다다른 현시점에서 중요성이 점점 더 커지고 있다. 특히, 새로운 부가가치를 만들 수 있는 핵심 기술로 주목받고 있다.
뉴스룸은 앞으로 총 11화에 걸쳐 <반도체 부가가치를 올리는 패키지와 테스트>라는 책을 근간으로 반도체 후공정 과정에 대해 살펴보고자 한다. 이번 연재가 업계에 입문하려는 학생들에게는 길잡이가 되는 지침서의 역할을, 유관 업무에 종사하는 분들에게는 이해도를 높이는 안내서의 역할을 할 수 있기를 바란다.(필자 주)
#1. 반도체 패키지 설계
<그림 1>은 반도체 패키지 설계의 업무 내용을 표현했다. 반도체 패키지 설계는 먼저 칩에 대한 정보인 칩 패드(Chip Pad) 좌표, 칩 배열(Layout), 패키지 내부 연결(Package Interconnection) 정보들을 칩 설계 부서로부터 받아야 한다. 그리고 패키지 재료에 대한 정보를 기초로 패키지 양산성, 제조 공정, 공정 조건, 장비 특성이 고려된 디자인 규칙(Design Rule)을 적용하여 반도체 패키지 구조와 서브스트레이트, 리드프레임 등을 설계한다. 이때 패키지 개발 과정에 따라 설계 업무 산출물이 나오는데, 개발 초기에 패키지 가능성을 검토 후 칩 및 제품 설계자들에게 피드백해야 한다. 가능성 검토가 완료되면, 패키지(Package) 도면, 툴(Tool) 도면, 리드프레임(Leadframe) 도면, 서브스트레이트(Substrate) 도면을 작성한 후, 제작업체에 주문해서 웨이퍼 공정이 완료된 웨이퍼가 패키지 공정에 도착하기 전에 툴과 리드프레임 재료, 서브스트레이트들을 준비해야 한다. 그리고 패키지 공정을 위해서 와이어 또는 솔더 범프 연결을 위한 도면을 작성하여 패키지 공정 및 제조 엔지니어들에게 미리 공유해야 한다.
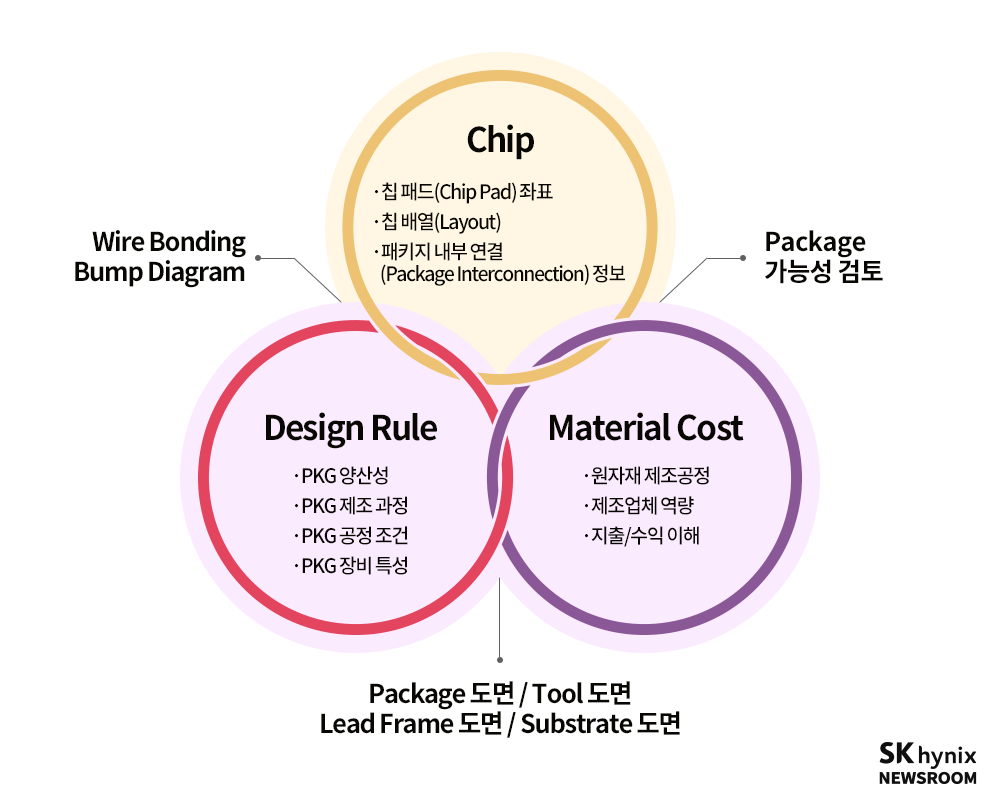
▲ 그림 1 : 반도체 패키지 설계의 업무 내용(ⓒ한올출판사)
이러한 업무 내용 때문에 반도체 패키지 설계 엔지니어들은 시스템 업체에서 요구하는 패키지 솔 볼 배열(Layout)과 칩의 패드 배열(Sequence)을 배선이 가능한지 연결해보고, 가검토(Pre-Design)를 통해 반도체 칩/소자의 특성/공정에 유리하게 패키지 솔더 볼 배열, 패키지 크기 및 스펙(Spec)을 제안한다. 아래 <그림2>와 같이 패키지 가능성 검토 초기 단계에서 최적의 패드(Pad) 배치를 제안하고 배선 가능성(Route-Ability) 확보와 특성/작업성 최적화 작업을 한다.

▲ 그림 2 : 반도체 패키지 설계의 업무 과정 – 가능성 검토 → 배선 가능성 검토 → 패키지 최적화 설계(ⓒ한올출판사)
패키지 설계 단계에서는 전기적/기계적/공정 최적화를 위해 전기 해석, 구조 해석, 열 해석을 진행한다. 전기적 특성, 열 특성이 최적화되고, 공정도 최적화될 수 있게 설계에 반영하는 것이다. 또한 품질 문제 예방을 위하여 소재/공정/장비를 고려한 설계 규칙(Design Rule)을 만들고, 주기적으로 점검하여 필요시 제정 및 개정한다.
고속화, 고집적화, 고성능화되어가는 반도체 업계의 요구를 충족하기 위해 패키지에서 솔더 볼을 만들어 패키지와 PCB 기판을 연결하는 핀의 수는 늘리고, 더 많은 배선을 넣어서 전기 특성을 강화하고 있다. 이 때문에 기판 서브스트레이트, 리드프레임, PCB 등의 설계는 점점 더 미세하고 복잡해지고 있다. 하지만 이에 대한 대응은 한계가 있다. 패키지 업체뿐만 아니라 기판 등을 제조하는 제조사의 공정 능력에 따라 다르기 때문이다. 이에 패키지 설계에서는 규칙을 만들어 칩 설계자, 기판 제조사, 패키지 공정과 소통하면서 관리하며 주기적으로 업데이트한다.
예를 들면, 패키지 공정 엔지니어와 서브스트레이트 제조사의 공정 엔지니어들은 시스템에서 요구하는 전기적 특성 요구치를 만족하기 위해서 패키지용 솔더 볼에 대한 크기와 간격(Pitch) 및 신호 배선의 넓이(Width)와 배선 간 간격(Space)을 줄이기 위해 노력하고 있다. 또한, 도면을 설계할 때 관리하는 설계 규칙에는 패키지의 공정 능력 한계치에 대한 공차* 관리와 기판 제조 업체에서 제공 가능한 서브스트레이트의 공차 관리 사항 등이 물리적인 규격으로 지정되어 있다.
* 공차 : 작업 능력치에 따라 생기게 되는 수치나 공간의 에러 범위
공정 능력 외에 전기적 규격이 까다로운 제품군이 요구하는 전기적 특성을 만족시키기 위한 공차 관리도 지정한다. 즉, 도면으로 관리하여 공정 능력부터 전기적 규격까지 관리 항목을 지정하고 있다. 전기적 규격을 맞추기 위해 사전 검증된 설계 데이터를 기반으로 도면화하여 ①각 고속용 신호 배선(High Speed Signal Line)에 대해 관리 및 공차 지정, ②각 신호 배선(Signal Line)의 임피던스(Impedance) 정합성 관리를 위한 유전체 두께 관리 및 공차 지정, ③최적의 저전력(Low power) 설계를 위한 비아 크기 및 관리 공차 지정을 순차적으로 진행한다.
또한, 패키지 공정 시 공정 효율과 양산성을 높이기 위해서 기준 표시 패턴을 서브스트레이트 등을 설계할 때 고려하고, 설계 규칙으로 관리한다.
#2. 구조 해석
전산 모사 해석은 특정 상황에서의 현상을 이해하고자 이미 도출된 일반식을 특정 조건에 적용하고, 이를 전산(Computing)의 힘을 빌려 해를 도출하는 것으로, 다음 4단계로 진행된다.
먼저 ①자연 현상을 지배하는 인자와 인자 간의 관계를 수학적으로 표현하며(지배 방정식-Governing Equation), ②해석의 대상이 되는 현상을 전산 모사가 가능하도록 모델링하고, ③이 모델에 지배방정식을 적용하여 수학적으로 계산하며, ④그 결과를 현상에 적용하여 분석(Analysis)하는 것이다. 전산 모사 해석의 방법은 크게 유한차분법/유한요소법/유한체적법 등으로 구분된다. 반도체 구조 해석에서는 유한요소법(FEM, Finite Element Method)이 가장 널리 사용된다. 유한요소법의 공학적 의미는 무한(Infinite)개의 절점과 자유도를 유한(Finite)개의 절점과 자유도로 전환해 선형 연립방정식으로 구성해 전산으로 계산하는 방법이다.
해석 모델은 요소(Elements)라 불리는 유한개의 빌딩 블록(Building Block)들로 이루어진다. 각 요소는 유한개의 점과 지배방정식을 갖게 되며, 이 수식을 풀어 값을 얻는다. 구조 해석의 주요 항목을 이해하기 위해서는 몇 가지 용어에 대한 이해가 필수다. 가장 중요한 3가지만 설명하면 포와송 비(V: Poisson’s Ratio), 열팽창 계수(CTE: Coefficient of Thermal Expansion), 응력(Stress)이다.
물체를 길이 방향 양쪽에서 잡아당기면, 즉 물체가 인장력을 받으면 길이 방향으로 늘어나는 동시에 지름 방향으로는 수축한다. 마찬가지로 길이 방향 양쪽에서 누르면, 즉 물체에 압축력을 주면 힘의 방향으로 줄어들지만 지름 방향으로는 늘어난다. 이때 이 막대기의 길이 방향으로 단위 길이당 변화량과 지름 방향으로 단위길이 당 변화량의 비를 ‘포와송 비’라고 말한다.
온도 변화에 의해 재료의 길이가 변하는데, 일반적으로 온도가 상승하면 재료는 팽창하고 온도가 감소하면 재료는 수축한다. 그리고 보통 팽창이나 수축은 온도 증가나 감소와 선형적인 관계를 이룬다. 이는 ‘열팽창 계수’라 부른다.
응력은 물체에 외력이 작용했을 때 그 외력에 저항하여 물체의 형태를 그대로 유지하려고 물체 내에 생기는 내력을 의미하며, 단위는 압력으로 표현된다.
반도체 패키지에서 구조 해석을 활용하는 주요 항목 중 가장 대표적인 3가지는 패키지의 휨(Warpage), 솔더 접합부 신뢰성(Solder Joint Reliability) 그리고 패키지 강도인데, 이들에 대해 간략히 설명하겠다.
◎ 휨(Warpage) 해석
패키지 공정 중 온도가 인가되고 다시 상온으로 온도가 감소함에 따라 이종 재료 간의 열팽창 계수에 차이가 생기고 패키지가 휘어지며 불량이 발생할 수 있다. 그래서 제품의 구조 및 재료의 탄성 계수(Elastic Modulus)*, 열팽창 계수, 공정 온도와 시간 등을 인자로 구조 해석을 진행하면 휨을 예측하고 불량이 발생하지 않게 개선할 수 있다.
* 탄성계수(Elastic Modulus) : 고체 역학에서 재료의 강성도(Stiffness)를 나타내는 값으로 응력과 변형도의 비율로 정의
◎ 솔더 접합부 신뢰성(Solder Joint Reliability)
솔더는 반도체 패키지와 PCB 기판 사이에서 기계적·전기적 연결 역할을 한다. 솔더 접합부의 신뢰성은 매우 중요하며 패키지를 만들기 전에 구조 해석을 통해 솔더 접합부의 신뢰성을 분석하여 패키지 구조나 재료를 개선, 솔더 접합부의 신뢰성을 확보해야 한다.
솔더의 파괴 기구(Failure Mechanisms)는 주로 평면 방향의 수축에 의한 전단(Shear) 균열과 축 방향 인장에 의한 인장(Tensile) 균열의 조합으로 나타난다. 솔더 접합부에 대한 구조 해석은 여러 공정 조건이나 사용 조건에서 솔더 접합부에 인가되는 응력의 정도를 해석하여 진행한다.
◎ 강도 해석
패키지는 외력으로부터 칩을 보호하는 기능을 하며, 외력에 대한 강건성을 대표하는 것이 패키지 강도이다. 제품의 강건성 판정을 위해서는 일반적으로 3점 구부림(3 Point Bending) 또는 4점 구부림(4 Point Bending)과 같이 만능재료시험기(UTM)*를 활용한 패키지 강건성 시험을 실시하여 파단 강도를 구한다. 구조 해석에서는 이러한 만능재료시험기 시험을 모사하여 패키지 각 영역에서의 응력을 도출하고, 특정 소재의 파단 강도를 참고(Reference)로 하여 제품의 파단 강도를 예측한다.
* 만능재료시험기(UTM) : 재료의 강도를 측정하는 장비로 설정 하중으로 시험편을 당기거나 압축하여 인장강도, 굽힘 강도, 압축 강도를 측정하는 시험기
#3. 열 해석
전자 기기는 동작 시 전력을 소모하며 열이 발생한다. 이때 발생한 열로 반도체 제품을 포함한 부품의 온도도 상승하는데, 이것은 전자 장비의 기능/신뢰성/안전성에 문제를 일으킨다. 그러므로 전자 장비는 적절한 냉각 시스템을 통해 어떠한 환경에서도 부품의 온도를 특정 수준 이하로 유지할 수 있어야 한다.
이 때문에, 효과적인 열 발산이 반도체 패키지의 중요한 역할 중 하나가 된다. 따라서 동작 시 칩에서 발생하는 열과 패키지 재료 및 구조의 열 발산 효과, 그리고 반도체 패키지가 시스템에 적용되었을 때 환경에 의한 온도 영향 등을 열 해석을 통해서 정확히 이해하고, 패키지 설계 시에도 미리 반영해야 한다.
반도체 패키지에서 열 해석을 시행하고 활용하기 위해선 먼저 패키지의 주요 온도 지점을 정의할 필요가 있다. 패키지의 주요 온도 지점은 Ta(주변(Ambient) 온도), Tj(정션(Junction) 온도), Tc(케이스(Case) 온도), Tb(보드(Board) 온도) 등인데, <그림 3>에서는 패키지 모식도의 각 온도 지점을 표시하였다.
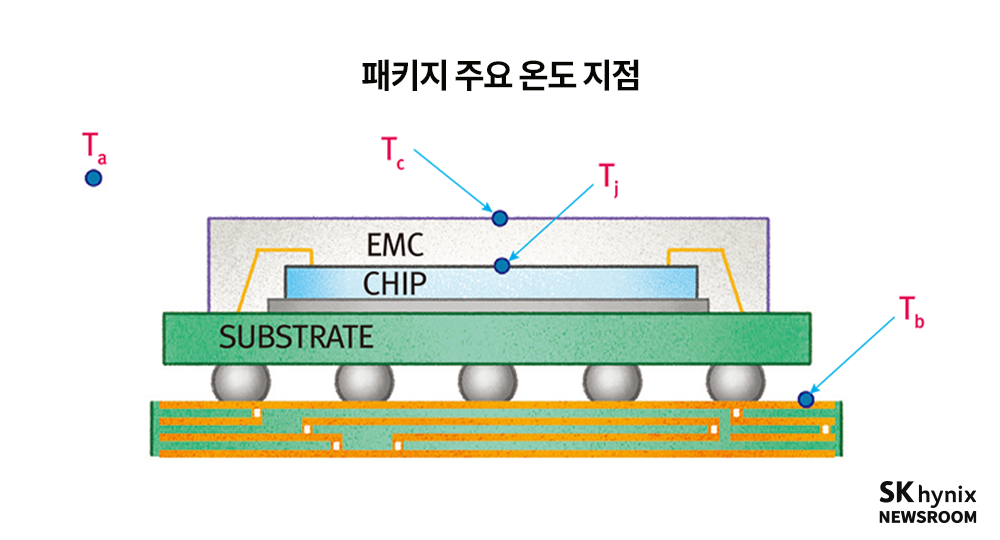
▲ 그림 3 : 패키지의 주요 온도 지점(ⓒ한올출판사)
보통 패키지의 온도 스펙을 이야기할 때 온도는 Tj,max 또는 Tc,max 이다. 이는 반도체 소자의 정상 동작을 보장하는 최대 온도를 의미한다.
패키지에서 가장 중요한 방열 특성은 패키지 열 특성(Thermal Characteristic or Thermal Resistance)이다. 패키지 열 특성은 1W의 열이 칩에서 발생할 때 반도체 제품의 온도가 주변 온도 대비 얼마나 증가하는지 나타내는 지표로, 단위는 [℃/W]다. 패키지 열 특성은 제품마다, 환경 조건마다 달라진다. 대표적인 열 특성 종류는 ja, jc, jb 등이 있으며, 이들의 정의는 [표 1]에서 확인할 수 있다. 이 값으로 열에 대한 패키지의 저항, 내성 등을 알 수 있다.

▲ 표 1 : 패키지 열특성 종류(ⓒ한올출판사)
#4. 전기 해석
반도체 칩이 고속화, 고밀도화되면서 반도체 전체 제품의 특성을 만족시키는 데 패키지도 큰 영향을 준다. 특히, 고성능의 반도체 칩을 패키지로 만드는 경우, 패키지 상태에서 정확한 전기 해석(Electrical Simulation)이 반드시 필요하다. 전기 해석은 모델을 만들고, 이를 이용해 고속 디지털 시스템에서 데이터 전송 타이밍(Timing)과 신호의 품질(Quality), 형태의 정확성을 예측한다.
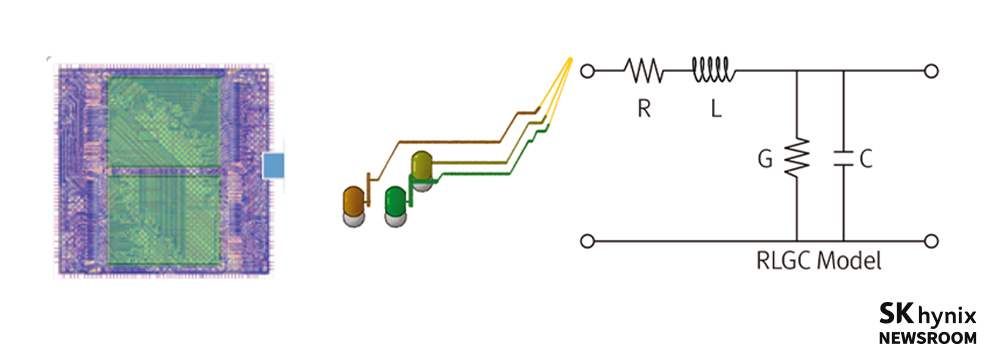
▲ 그림 4 : 패키지 RLGC 모델의 예(ⓒ한올출판사)
패키지 전기 해석을 위한 전기 모델의 기본 요소는 저항(Resistance), 인덕턴스(Inductance), 캐패시턴스(Capacitance)이다. 저항은 전류의 흐름을 방해하는 정도로, 물체에 흐르는 단위 전류에 반비례한다(단위: Ω). 인덕턴스는 회로에 흐르는 전류의 변화에 의해 전자기유도로 생기는 역기전력의 비율(단위: H)이다. 그리고 캐패시턴스는 전하를 저장할 수 있는 능력을 나타내는 물리량으로 단위 전압에서 축전기가 저장하는 전하(단위: F)이다. 전기 해석 시 패키지는 RLGC 모델로 표현하며 위의 <그림 4>는 RLGC의 모델 예를 보여준다.

▲ 그림 5 : 전기 해석 영역(ⓒ한올출판사)
그리고 RLGC 모델을 활용해 <그림 5>에 나타낸 것과 같이 가장 중요한 특성들인 SI(Signal Integrity)*, PI(Power Integrity)** 그리고 EMI(Electromagnetic Interference)*** 특성을 예측한다.
* SI(Signal Integrity) : 신호 무결성으로 전기 신호의 품질에 관한 척도
** PI(Power Integrity) :파워가 손실 없이 전달되는 정도로 파워 전달의 품질에 관한 척도
*** EMI(Electro-magnetic interference) : 전자파 간섭 또는 전자파 장애로 방사나 전도되는 전자파가 다른 기기의 기능에 장애를 주는 것




