
원자격자배열이 111 혹은 100인 p-도펀트 타입 웨이퍼가 연마를 마치고 반도체 제조 라인으로 들어오면, 제일 먼저 웨이퍼 위에 N-Well 1개를 마련합니다. 일반적으로 동작은 트랜지스터(Tr) 2개를 쌍으로 동작시키는 CMOSFET를 구성하므로 N-Well에 Tr 1개, Well 옆에 추가로 Tr 1개를 위치시킵니다. (혹은 P-Well, N-Well 1개씩 총 2개 Well을 설치해 각 Well에 1개씩 Tr를 만들기도 합니다) Tr을 만드는 것은 단자 3개를 형성하는 것이고, 단자를 형성한다는 것은 단자 영역과 단자 외 영역을 구분해 불순물 농도를 다르게 둔다는 것입니다. 소스/드레인 단자를 만들 때 초창기에는 확산 방식을 적용했다면, 지금은 정확도를 더 높인 이온-임플란테이션 방식을 사용합니다. 오늘은 이온-임플란테이션의 장점인 도핑 농도 조절과 소스/드레인 형태 조절의 용이성에 대하여 알아보고, 그 반대로 단점인 결정격자가 파괴되는 현상과 이를 극복하는 과정에 대해서도 함께 살펴보도록 하겠습니다.
양이온 생성: 열전자 방출
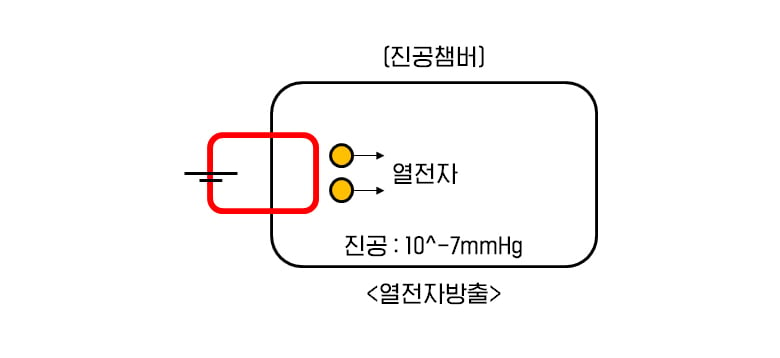
불순물을 웨이퍼에 도핑하는 이온-임플란테이션은 먼저 매개체인 이온부터 만들어야 합니다. 음이온도 사용 가능하나, 주로 만들기 더 손쉬운 양이온을 사용합니다. 중성원자에 전자를 붙이는 것은 떼어내는 것보다 훨씬 복잡합니다. 더군다나 중성원자에 붙여놓은 전자는 순식간에 떨어져 나가기 때문에 음이온의 생명시간이 양이온보다 짧습니다. 양이온을 만들기 위해 준비해야 할 도핑 원재료는 BF3, PH3, AsH3 등 13족 혹은 15족 원소계열이 포함된 화합물분자 기체가스입니다.
이온은 먼저 필라멘트에서 튕겨져 나온 열전자를 가속시킨 후, 도핑재료인 화합물분자 기체가스에 높은 에너지로 열전자를 충돌시켜 만듭니다. 필라멘트는 집에서 사용하는 백열전구 속 구불구불하고 가느다란 텅스텐 금속선과 거의 유사합니다. 이 필라멘트에 전류를 흘리면 의도적으로 높인 저항으로 인해 열이 발생되는데요. 이때 발생되는 열에너지를 받아서 금속원자가 끼고 돌렸던 전자들이 쉽게 금속원자핵의 구심력을 이겨내고 탈출합니다. 이렇게 열을 받은 전자가 방출하는 현상을 ‘열전자 방출’이라 합니다.
양이온 생성: 열전자 충돌
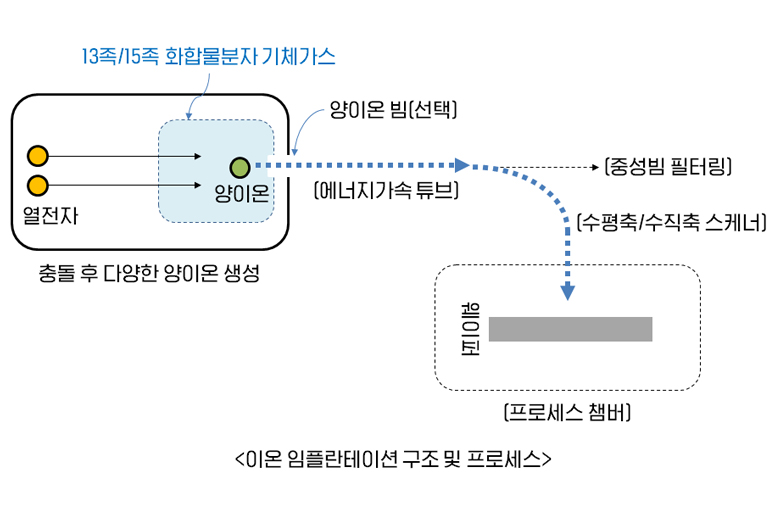
열전자를 도핑의 원재료인 화합물분자 속에 가속시키면, 열전자가 전기적으로 중성인 화합물분자(BF3, PH3, AsH3 등)와 충돌하게 됩니다. 이후 화합물분자는 충돌에너지를 받아 여러 형태로 쪼개지는데요. (입자가 충돌하여 피충돌 입자가 분리되는 맥락은 원자폭탄 원리와 동일합니다만, 원자폭탄은 핵이 분리되는 반면 여기서는 원자 내에 소속된 전자 하나가 분리되는 정도입니다. 두 경우의 에너지 차이는 극과 극입니다) 이때 원자 속에 소속된 최외곽전자 하나가 튀어나와 임플란테이션에 필요한 양이온이 만들어집니다. 불순물로 도핑할 원재료인 화합물분자 가스와 충돌시키는 매개체로는 전자만 가능한 것이 아닙니다. 다른 중성원자나 특별한 이온들도 가능하지만, 주로 다루기 쉬운 전자를 이용하는 것이죠.
양이온 골라내기
열전자와 충돌한 화합물분자는 다양한 형태의 양이온으로 쪼개집니다. 그중에서 임플란테이션에 사용할 적절한 질량의 양이온(13족은 붕소 1가지를 사용하고 15족 3가지 중에 하나를 적절히 사용)을 선별합니다. 양이온을 분류할 때는 자계(magnetic field, 자석)를 이용해 필요한 양이온만을 추출합니다. 이때 불필요한 원소들은 선택되지 못하도록 여러 가지 방법이 동원됩니다. 그렇지 않으면 임플란트시 불필요한 양이온들도 웨이퍼에 투사되어 소스/드레인 단자 내에 원하는 농도를 맞출 수 없게 되고, 도핑되는 불순물의 균일도도 떨어뜨리게 되죠. 이때 양이온은 실리콘 원자층을 어느 정도 뚫을 수 있는 것으로 선택되어야 합니다. 또, 어떤 경우는 실리콘 기판 상부에 형성되어 있는 절연 산화층을 뚫고 기판 속으로 들어와야 할 때도 있습니다.
양이온 빔 주입
웨이퍼에 양이온을 주입할 때는 조절이 쉽도록 반경 0.5cm 정도의 빔 형태를 이용합니다. 양이온 소스들을 가속시키면서 좁고 가느다란 슬릿을 통과하도록 하여 원하는 양이온의 빔을 뽑아냅니다. 가속된 양이온은 약 300keV 정도의 에너지(실질적으로는 100 ~ 10,000keV까지도 가능)를 갖도록 해 산화층을 통과시킵니다. 산화층은 약 1~2nm 정도 되므로, 이를 투과한 양이온들은 결국 산화층 하부의 p-type 기판 계면에서 약 100nm~몇 백 nm 혹은 1um까지 파고 들어갈 수 있도록 합니다. 실지로 적당한 위치에 불순물을 입체적으로 도핑하기 위해서는 임플란트를 여러 번 실시 해야 합니다. 한 번의 임플란트는 계산된 위치에서만 불순물이 집중(정규분포)되기 때문입니다. ▶<게이트 및 게이트 옥사이드층 만들기 : 전류구동에서 전압구동으로> 편 참조
테크놀로지가 발전할수록 산화층의 두께는 얇아지므로 같은 깊이로 양이온을 침투시킬 경우, 가속되는 양이온의 에너지도 줄일 수 있습니다. 갈수록 소스/드레인 단자의 부피가 줄어드는 추세인 만큼 임플란트 깊이도 얇아져 가겠죠. 이때 특히 이온 빔의 초점과 스케닝 지점을 원하는 웨이퍼 위치에 잘 맞춰 진행해야 합니다. 양이온 빔의 스케닝은 예전 TV의 브라운관 전자빔의 스케닝처럼 수평축과 수직축 방향으로 전계와 자계를 이용해 빔이 휘어지는 각도를 적절히 맞춰 진행합니다.
양이온 빔의 중성화
양이온은 불안정한 상태이기 때문에 어떤 환경에서는 쉽게 중성상태로 전환됩니다. 이온 빔이 형성되는 초기상태에서는 같은 공간에서 산포되어 있는 다른 분자상태의 기체가스들과 결합해 중성상태의 분자로 변하게 되죠. 중성으로 변하는 양이온들이 많을수록 임플란트의 효율은 저하됩니다. 이런 중성화된 가스들도 임플란트시에 함께 웨이퍼로 주입되므로, 이를 선별하기 위해 이온 임플란트 장비는 휘어진 형태를 갖춥니다. 중성화된 가스는 직진하도록 만들고 양이온 빔은 휘게 하여 분리시키는 것이죠.
이온-임플란트의 장점: 도즈와 깊이 조절 용이
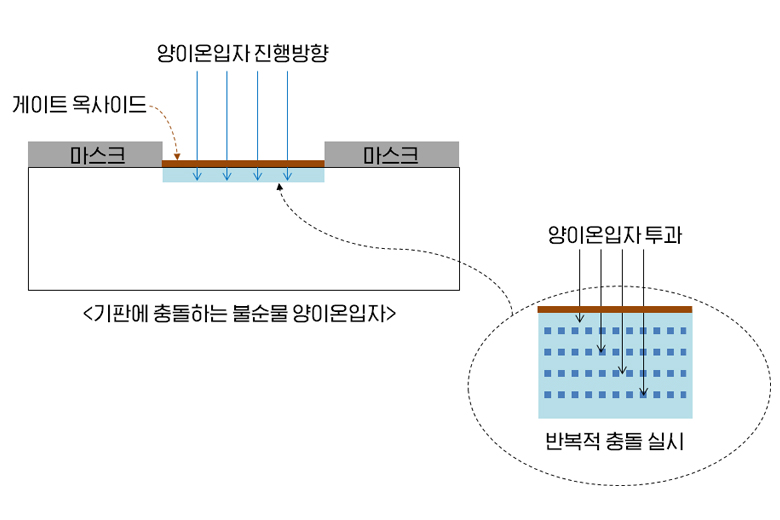
제곱 센티미터 면적당 1초 동안 웨이퍼에 파고 들어가는 불순물의 양을 ‘도즈’라고 합니다. 이온 임플란트는 확산방식에 비해 도핑하는 불순물 양과 입체적 도핑 위치를 정확히 계산할 수 있다는 장점이 있습니다. 특히 확산방식에 비해 적은 도핑량이 필요할 때 더욱 요긴하게 사용할 수 있고, 수평축으로 퍼지는 문제도 개선됩니다. 소스/드레인 단자를 만들 때는 약 10^19개/단위 세제곱 센티미터(cm^3)의 불순물 양이온을 투입합니다. 이는 실리콘 농도 10^22/cm^3 보다 약 1,000분의 1정도 되는 개수입니다. 빔 전류가 커지면 도즈가 커지고, 양이온을 가속시키는 전압이 크면 웨이퍼 계면 밑으로 파고 들어가는 양이온의 주행길이가 깊어집니다. 이온 임플란트 방식 이용 시에는 빔전류와 가속전압을 조절하면서 해당 테크놀로지에 알맞은 최적의 소스/드레인 단자를 만들어 낼 수 있습니다. ▶<확산 방식을 이용한 소스와 드레인 단자 만들기> 편 참조
이온 임플란트의 단점: 채널링
웨이퍼 실리콘이 질서 정연하게 배열돼 있으면, 실리콘 원자와 원자 사이의 빈 공간으로 양이온이 원하는 깊이보다 더욱 깊게 들어갈 수 있습니다. 이를 양이온의 ‘채널링’ 현상이라 합니다. 채널링은 어느 일정 깊이까지만 도핑을 해야 하는 경우, 농도의 값을 떨어뜨리고 균일성도 안 좋아집니다. 이를 방지하기 위해서는 일정 깊이에서 양이온의 이동을 막아야 하는데요. 웨이퍼를 움직여 양이온의 입사 각도를 조절해 실리콘 원자들이 양이온의 진로를 막아서게 하거나, 양이온이 웨이퍼에 파고 들어가는 깊이를 얇게 하기 위해 임플란트의 주입 에너지를 줄이는 방법이 있습니다. 혹은 불순물 타입을 다른 종류로 변경하는 방법도 있습니다. (불행히도 13족은 붕소 이외에 대체할 불순물이 없습니다)
양이온과의 충돌에 의한 실리콘 원자 격자배열의 파괴
일정한 에너지 이상을 보유한 양이온이 실리콘 원자와 충돌하면 일부 실리콘 원자는 원래의 위치에서 벗어나게 됩니다. 이런 현상을 실리콘 격자가 데미지를 받았다고 표현하죠. 이온- 임플란트를 행한 모든 실리콘은 어떤 형태로든 일정 부분 손상을 입게 되는데요. 손상된 원인은 매우 다양하며, 손상의 범위나 형태도 여러 가지로 나눌 수 있습니다.
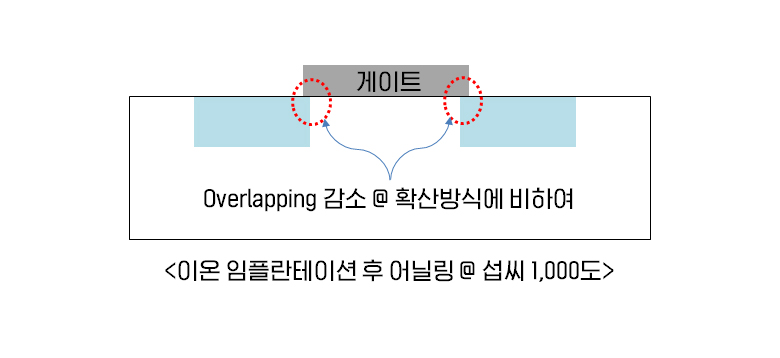
양이온을 임플란트한 이후에는 데미지를 입은 웨이퍼를 최대 약 섭씨 1,000도 가까이 가열하는 ‘어닐링(열처리)’을 실시합니다. 어닐링은 정위치에서 벗어난 실리콘 배열이 제자리를 찾아가게 합니다. 또, 어닐링은 실리콘 원자를 치환하려 하는 불순물 원자가, 박힌 돌(실리콘 원자)을 빼고 실리콘 원자가 있었던 위치에 들어설 수 있게 도와주죠. 섭씨 500도에서부터 온도를 높일수록 개선되는 부위가 점점 늘어나게 되며, 섭씨 1,000도 근방까지 가서는 거의 대부분의 데미지들이 회복된다고 볼 수 있습니다. (반도체 공정에서는 어떤 경우든 실리콘이 녹는 섭씨 1,400도까지 높이는 일은 없습니다) 어닐링은 오랜 시간 실시하는 방법도 있고, 좀 더 발전된 방법으로는 빠른 시간 내에 실시하는 RTA방법(Rapid Thermal 어닐링)이 있습니다. ▶<반도체 속의 전자 여행 : 자유전자의 탄생> 편 참조
절연체에 가까운 순수실리콘만으로는 웨이퍼는 아무 기능을 하지 못합니다. 이 속에 전자가 움직일 수 있도록 외부에서 불순물을 불어넣어야 TR이 다양하게 반응할 수 있죠. 이처럼 도핑은 죽어있는 뻣뻣한 나무토막에 영혼을 불어넣는 역할을 한다고 볼 수 있습니다. 그런 도핑 방법도 진화를 거듭해 확산방식에서 이온-임플란테이션 방식으로 발전했습니다. 정확한 양의 불순물을 투입할 수 있다는 장점을 가진 이온-임플란테이션 방식은 소스/드레인 단자를 만드는 것뿐 아니라, 그 응용범위가 점점 넓어져서 문턱전압을 조절하기 위해서도 적용되고 있습니다. 또, Well을 만들 때도 유용하게 쓰이고 있답니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.



