
게이트 옥사이드는 게이트와 채널 사이에서 전류의 흐름을 막아내고 전압을 대신 전달하는 역할을 합니다. 게이트 옥사이드막을 활용하기 전까지 트랜지스터는 당연히 전류를 흘려서 동작시키는 것이 상식이었는데요. 그런 전류 구동인 BJT(Bipolar Junction Transistor)에 반대하여 전류의 흐름을 막은 장본인이 게이트 옥사이드랍니다. 게이트 옥사이드는 전류를 막는 대신 전압을 게이트 단자에 인가/전달하여, 전압 구동인 FET(Field Effect Transistor)의 핵심적인 기능을 수행하는 층이라고 할 수 있습니다. 이번 장에서는 게이트 단자와 게이트 옥사이드를 Fab Line에서 동시에 만들어보도록 하겠습니다.
게이트 단자와 게이트 옥사이드의 구성 1단계 : 포토공정
지난 장에서는 STI의 형태를 만들었는데, 게이트 단자와 게이트 옥사이드 역시 이와 유사한 방식으로 회로패턴을 형성시킵니다. (‘산화막, 전자 이동을 막는 이상적인 절연막’ 편 참조) 먼저 게이트와 게이트 옥사이드의 형태를 만들기 전에, 실리콘 웨이퍼 표면상에는 산화층이 매우 얇게(약 1nm ~ 1.2nm) 덮여 있어야 하고, 그 위에 게이트층이 증착방식으로 한 층 형성한 후에 시작합니다. 게이트단자와 게이트 옥사이드는 층만 형성되어 있다면, Fab 공정 상 동시에 만드는 것이 공정 스텝을 절약할 수 있지요.
1-1. 포토 – PR용액 도포
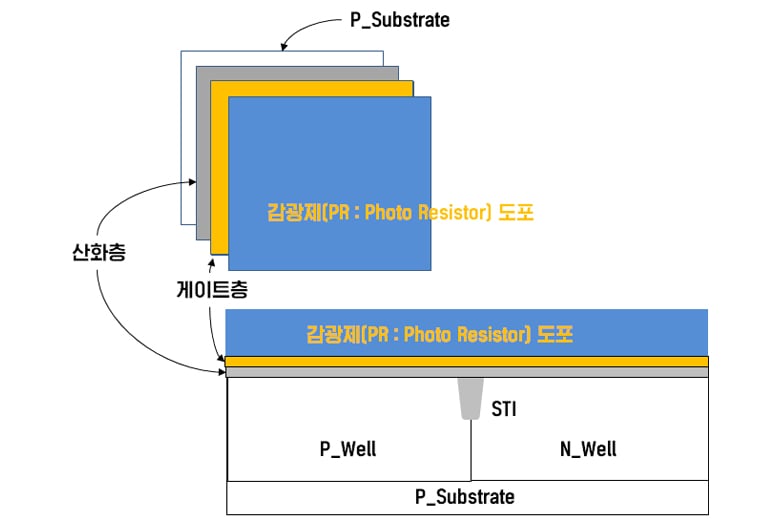
▲포토공정-감광재 도포
포토 공정의 첫 단계로 감광액(Photo Resist, PR)를 코팅합니다. PR액은 실리콘 기판에 잘 붙지 않기 때문에 HMDS라는 접착제를 먼저 발라야 합니다. HMDS는 묽기 때문에 웨이퍼 표면에 스핀(웨이퍼 회전)방식이 아닌, 질소 가스 압력을 이용해 웨이퍼 위에 퍼지게 해야 합니다. 반면 PR액은 수지(Resin)와 솔벤트가 섞여 있어 어느 정도 점도를 갖고 있기 때문에 웨이퍼를 분당 약2,000회(RPM) 정도로 돌려 웨이퍼 위에 골고루 펴바릅니다. 이는 마치 미술의 동판화(부식기법)에서 구리판 위에 방식제(그라운드, 코팅액)를 바른(코팅) 형태와 같다고 볼 수 있습니다. PR액이 스핀 되면 웨이퍼 끝자락에 PR액이 묻어 있기 때문에 이를 신너로 제거해야 다음 공정을 진행하기가 편합니다(Edge Bead Removal). 그런 후 PR액이 더 이상 흘러내리지 않도록 약한 온도로 웨이퍼를 Bake합니다(Soft Bake).
1-2. 포토 – Layer 구분
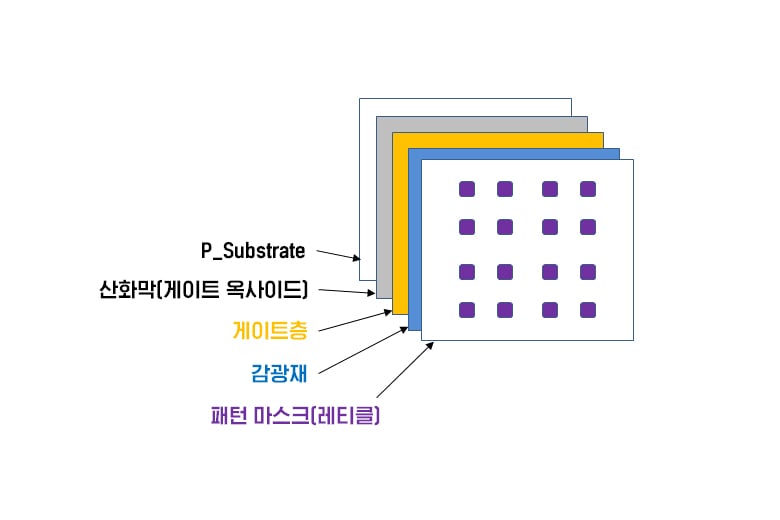
▲Layer 구분
이해를 돕기 위해 각 Layer의 순서와 명칭을 알아보겠습니다. 맨 밑에는 웨이퍼인 기판(Substrate)이 있습니다. 기판 위에는 1차 산화막과 게이트 단자에 사용할 게이트 막이 건식 산화방식(산화막)과 증착방식(LP CVD : 대기압의 약 10분의 1정도의 압력에서 화학적 방식으로 증기를 형성하여 게이트 단자막을 증착)으로 얇게 덮여 있습니다. 또 그 위에는 감광된 부위를 현상하기 위하여 감광재(PR)가 코팅되어 있습니다. 감광재 위에는 노광 시 패턴을 구사하기 위하여 빛을 투과시키는 마스크가 놓이게 됩니다.
1-2-1. 포토 – 마스크의 정렬
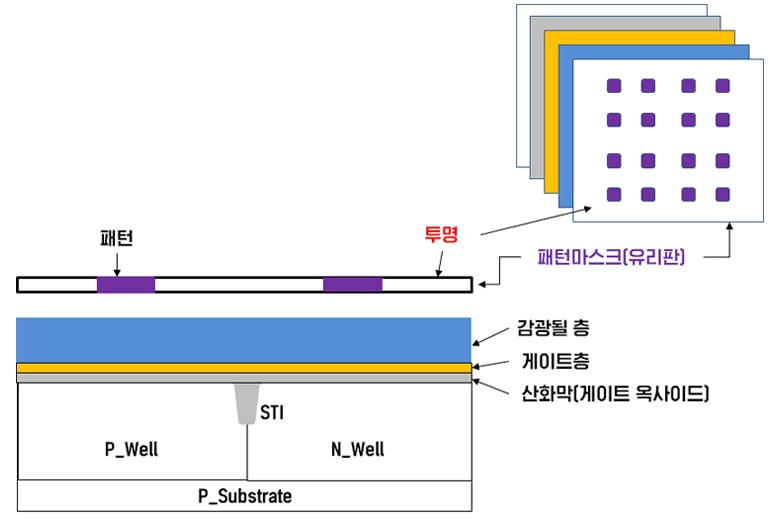
▲포토공정-마스크와 웨이퍼의 위치정렬
빛으로 판화를 찍으려면 마스크와 웨이퍼를 일직선 상으로 정렬해야 의도한 마스크의 패턴 위치가 제대로 웨이퍼 위에 내려앉습니다. 정렬방식은 현재까지 진화를 거듭해왔습니다. 마스크와 웨이퍼 사이는 처음에는 틈이 없도록 붙이는 방식(접촉방식)을 사용했다가, 웨이퍼 상에 오염이 나타나자 마스크와 웨이퍼의 간격을 일정 거리로 벌리는 방식(근접방식)을 적용했습니다. 그러나 근접방식도 감광액 표면에 맺힌 상이 빛의 난반사로 인해 패턴의 초점이 명확하지 않는 등의 문제점이 발생하게 되죠. 그래서 지금은 웨이퍼와 마스크 사이를 난반사가 발생하지 않을 정도의 약간 먼 거리의 프로젝션 방식을 대부분 채택하고 있습니다.
1-3. 포토 – 빛에 노출시키기(노광)
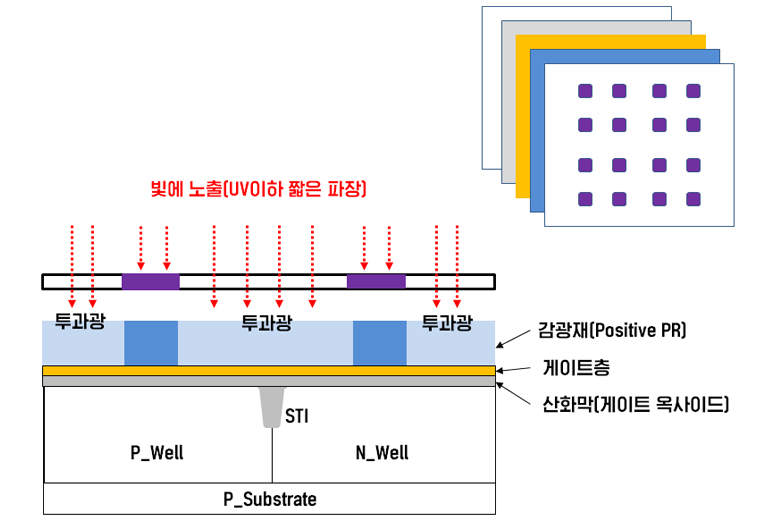
▲포토공정-노광
노광은 PR막을 빛에 노출시켜 감광시키는 공정입니다. 판화는 잉크를 동판에 묻혀 도화지 위에 사람이 직접 꾹 눌러 찍어내지만, 반도체에서는 좀 더 복잡한 과정(순서도 다르고요)을 거쳐서 영상(패턴)을 도화지(웨이퍼) 위에 옮겨 놓습니다. 먼저 감광된 부분이 회로가 되거나 회로의 반대 영역이 됩니다. 노광은 포토 공정의 하이라이트이며, 반도체 전 공정을 통틀어 가장 중요한 스텝이라고 할 수 있습니다. 빛이 마스크를 통과하느냐 못하느냐로 반도체 테크놀로지가 결정되기 때문입니다. 광선을 선택할 때의 기준은 주기적 성질을 갖는 파의 길이인 파장이 매우 중요합니다. 파장은 점점 작아지는 방향으로 가야 하기 때문입니다. Technology가 발전한다는 것은 패턴이 좁아진다는 것이고, 이는 마스크의 면적과 면적 사이가 점점 좁아진다는 것입니다. 좁아진 틈을 통과하려면 빛의 파장이 그 틈을 뚫고 지나갈 만큼 작아야 하고요. 최근에는 극초단파(Extreme Ultra Violet, EUV)의 파장을 적용한 장비가 사용되고 있습니다.
1-3-1. 포토 – 노광 후 굽기(PEB)
노광기에서 노광을 마친 웨이퍼는 다시 트랙(Track)장비로 되돌아와 현상을 진행해야 하는데, 현상 전에 감광된 웨이퍼는 다시 약하게 bake합니다. 이를 노광후굽기(Post Exposure Bake, PEB)라고 합니다. 감광된 부분과 감광되지 않은 부분 사이의 벽인 경계면은 거칠고 울퉁불퉁한 상태가 되는데요. 이때 웨이퍼를 약한 온도로 올려 어느 정도 데우면 감광된 요철 부위가 어느 정도 일직선으로 펴지게 됩니다.
1-4. 포토 – 현상
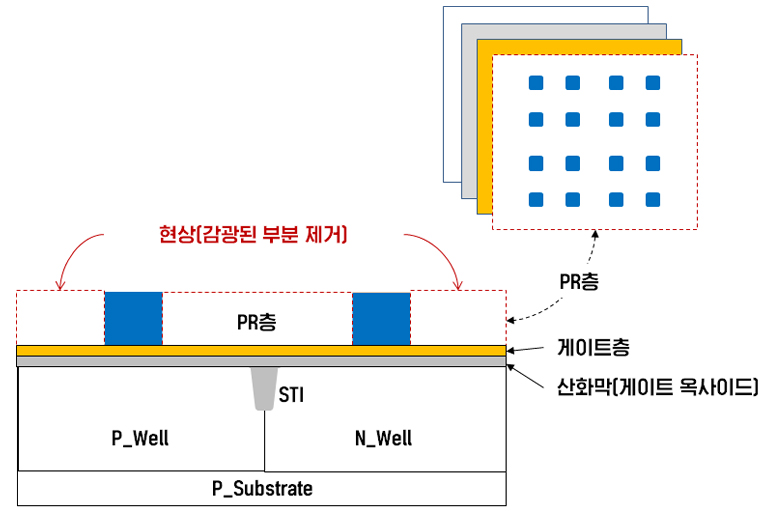
▲포토공정-현상
노광 후 굽기 과정이 끝나면 본격적으로 현상을 진행합니다. 현상에는 2가지 방법이 있는데요. 첫째는 감광된 부분을 제거하는 방식, 둘째는 감광되지 않은 부분을 제거하는 방식입니다. 감광된 부분을 없애도록 설정된 PR은 Positve PR, 그 반대를 Negative PR이라고 합니다. 즉 감광된 부분이 약해져서 이 부분을 파내거나(Positive PR), 반대로 감광된 부분을 딱딱하게 만들어 감광되지 않은 약한 영역을 파내는 것(Negative PR)이지요. 일반적으로 Positive 방식이 Negative 방식보다 공정방식이나 PR용액을 다루기 쉬워 더 자주 사용됩니다.
게이트 단자와 게이트 옥사이드의 구성 2단계 : 식각공정
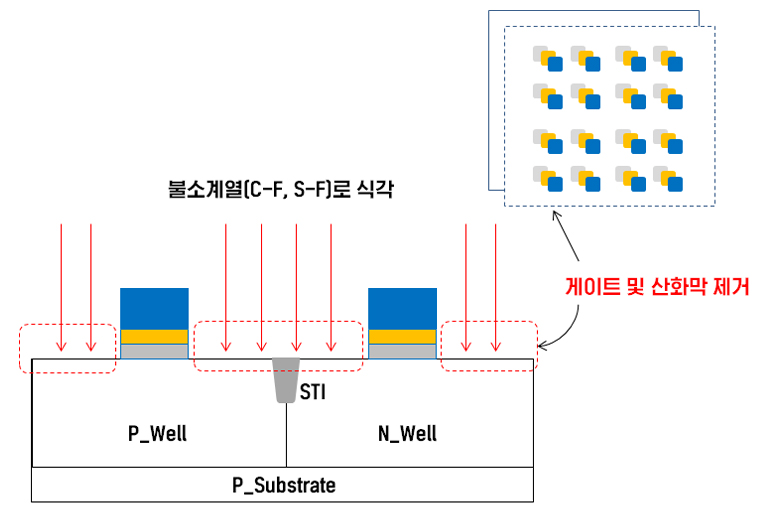
▲불필요한 막 식각
포토공정을 진행한 이유는 궁극적으로 식각을 위해서입니다. 식각을 동판화에 비유하자면, 조각칼로 방식제(코팅막)을 걷어낸(현상) 후에 드러난 구리판을 부식(식각)시키는 작업과 유사합니다. 현상으로 없어진 PR의 아래 부분은 대부분 박막(Thin Film : 절연막/Poly Silicon/Metal 등)층으로 드러나는데, 이 부분을 식각에서 집중적으로 제거합니다. 즉, 식각은 어떤 막이든 필요없는 부분을 없앤 후에 남는 나머지 부분 혹은 없앤 부분이 회로패턴이 됩니다. 그것이 어떤 때는 금속선이 되고, 어떤 때는 절연선 혹은 단자(터미널)가 되지요. 식각할 대상이 절연막인 산화막(SiO2)이면, 이는 산소라디칼(2O : 에싱에 쓰임)등에는 반응하지 않으므로 불소계열의 원소(C-F)로 절연막을 제거합니다. 반도체에 적용되는 막중에서는 절연막이 가장 강하고, 절연막 이외에는 좀 약한 금속층이나 폴리실리콘 층은 염소(Cl)계열 원소를 사용합니다.
게이트단자와 게이트 옥사이드의 구성 3단계 : 에싱공정
▲감광막 에싱
크게 보면 식각 공정에 속하기도 하는 에싱(Ashing)은 감광재인 PR 코팅막을 재로 날려버린다는 뜻입니다. PR을 없애주니 PR을 벗긴다는 의미로 PR Strip이라고도 하지요. 초창기에는 화학용액을 사용한 습식식각 형태를 이용하였으나, PR이 완전히 제거되지 않아 최근에는 플라즈마를 이용한 에싱을 합니다. 이때 주변에 노출되어 있는 실리콘 혹은 절연막 등 다른 막(물질)에는 반응을 하지 않는 선택비(Selectivity)가 좋은 산소가스를 이용한 플라즈마를 사용합니다. 따라서 감광막의 구성성분인 탄소에 산소원자를 과감하게 달라붙게 하여 일산화탄소나 이산화탄소로 만들어서 가스로 배출시키면 되지요.
게이트 단자와 게이트 옥사이드 완성 : 세정공정
▲게이트 단자 및 게이트옥사이드 완성
최종적으로 세정공정을 거치면 게이트 단자와 게이트 옥사이드가 완성됩니다. 세정은 각각의 공정이 완료된 후에 매번 실시되는데요. 가장 좋은 세정은 Fab 제조 공정을 진행하면서 발생된 오염이 표면에 달라붙지 않게 하는 예방입니다. 표면이 오염이 되면 이를 신속하고 확실하게 없애주는 게 가장 중요하지요. 그래야 다음에 후속으로 진행되는 공정이 전 공정으로부터 영향을 받지 않고 원활하게 진행될 수 있습니다. 막은 만드는(형태변경) 산화 공정이나 증착 공정은 각 공정이 완료 후에는 찌꺼기 등이 남지 않기 때문에 공정을 진행하기 전에 세정을 하고, 루틴 Fab 공정인 평탄화 공정과 건식각 공정은 각 공정이 완료 후에 찌꺼기 등이 남기 때문에 해당공정을 진행 한 후에 세정을 실시합니다.
게이트 단자나 게이트 옥사이드도 STI처럼 최종적으로 드러난 형태는 간단하지만 여러 공정을 거쳤습니다. 공정을 거쳐 완성된 반도체의 윗면과 옆을 잘라낸 단면은 무척 다른데요. 모든 반도체는 입체적인 구조를 가지므로 Cross Section과 Top View을 함께 해석해야 합니다. 반도체 Technology는 동작속도, 소비전력 등 여러 가지로 나타낼 수 있겠지만, Technology를 집적도로 표현한다면 주로 거리(Dimension)를 의미합니다. 이는 전자가 이동하는 채널 길이이자 소스와 드레인간의 폭이고, 또 게이트 길이입니다. 다르게 말하면 게이트 옥사이드 길이라고도 할 수 있습니다. 결국 이러한 요소들 중 맨 처음으로 만드는 게이트 단자나 게이트 옥사이드의 CD(한계치수)를 확보하는 것이 트랜지스터를 구성하는 첫 단추라고 할 수 있지요. 다음 시간에는 트랜지스터의 3개 단자 중에서 소스와 드레인 단자를 동시에 만드는 공정을 진행하겠습니다. 이렇게 하여 전체적인 트랜지스터 크기가 확보되면 칩의 용량이 최종적으로 결정됩니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.