
반도체가 실생활에 많이 활용되는 이유는 ‘쉬운 연금술’ 때문입니다. 절연체 성질을 갖는 물질에 약간의 화학적 물질을 첨가해, 절연체를 도체에 가까운 성질로 변화시킬 수 있죠. 도체를 통제하는 수단은 도체 외부에서 인가하는 플러스, 마이너스 전압의 2단 논리입니다. 하지만 반도체에서는 이것만으로는 원활히 사용하기 어렵습니다. 이때 공핍층은 중요한 매개수단이 되는데요. 오늘은 반도체의 활용도를 높여주는 공핍층에 대해 알아보려 합니다.
전압에 따라 변화하는 Gate 공핍층
트랜지스터는 외부 통제수단으로 6단 논리(NPN, PNP의 각 단자 +전압/-전압)를 적용하고, 또 내부 통제 수단으로 공핍층이 2개가 더 있습니다. 이렇게 총 8단의 논리를 이용하여 트랜지스터는 의도하는 어떠한 목적과 응용적인 측면에서 다양하게 활용할 수 있답니다. 따라서 공핍층은 트랜지스터/다이오드를 동작하는데 중요한 매개수단이지요. 물론 몇 가지 단점도 가지고 있지만, 그 단점까지 장점으로 적절히 이용하여 반도체의 활용도를 높이는 데 기여합니다.
일반적으로 트랜지스터의 공핍층은 제일 중요한 공핍층으로 P-N접합 혹은 N-P접합 사이에서 생성된 2개 공핍층(Source공핍층/Drain공핍층)이 있습니다. 그런데 ‘MOSFET공핍층’은 ‘Gate 공핍층’, ‘확산 공핍층’, ‘순방향 Bias 공핍층(Js)’, ‘역방향 Bias 공핍층(Jd)’ 4개로 세분할 수 있는데요. 이들의 상호작용을 통해 트랜지스터를 동작시킵니다. 먼저 ‘Gate 공핍층’을 살펴봅시다.
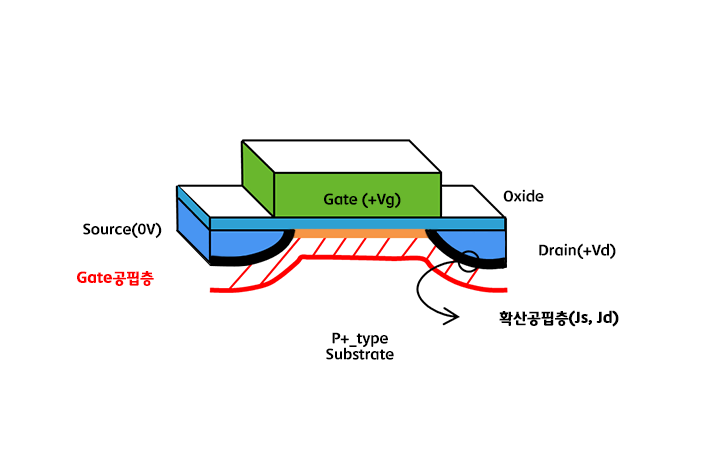
▲ Gate단자 하단에 광범위하게 형성되어 있는 Gate 공핍층
Gate단자에 +전압을 인가(Source와 Drain은 0V)하면서 Substrate는 약간의 -전위(Sub 보호)를 둡니다. 그러면 P_substrate단자 내 소수 캐리어인 전자들이 Gate단자의 +전압에 이끌려 P_sub단자 상단으로 갑니다. 전자가 있던 빈자리는 +로 대전된 층이 외롭게 남게 되지요. 전자가 결핍된 이 공핍층은 Gate단자에서 멀어질수록 농도가 약해집니다. 전자들은 P_sub 상단 경계면에 밀집해 옹기종기 모이고요. 마치 모이를 뿌린 수면 아래에 물고기가 모이듯 말입니다. (이 전자층이 다음 장에 소개할 n-Channel입니다. 전자들이 Source에서 Drain으로 건너갈 때 다리 역할을 하지요.)
P_sub내 +로 대전 된 정공층은 Gate전압으로 인해 탄생하여 ‘Gate 공핍층’이라고 부릅니다. Substrate공핍층이라고 해도 되지만 Sub 영역에는 트랜지스터 내부 동작 순서에 따라 확산 공핍층→Gate 공핍층→바이어스 공핍층(순방향, 역방향) 순으로 여러 개의 공핍층들이 등장하므로 각 공핍층을 구분하여 부르는 것이 혼돈을 방지하는 데 도움이 되겠지요. P_sub내에 존재하는 정공들은 전자가 빠져나가서 형성한 인위적인 정공들(+극성으로 대전된 원자집단인 공핍층)과 초창기 P_type 불순물 반도체를 만들며 자연스레 생성된, 다수 캐리어라고 부르는 정공들(중성 원자집단)로 구성됩니다.
보통 P_sub을 형성하는 불순물농도는 Source/Drain단자(불순물 원자수가 ㎤당 약 10^18 ~10^20 개)에 비해 약 1천분의 1배에서 10만분의 1배로 약하게 형성됩니다. 이에 불순물농도에 반비례하는 ‘Gate 공핍층’ 두께는 확산 공핍층에 비해 넓게 형성됩니다. 또한 Gate단자 전압 변화(AC성분: small signal 진폭)에 따라 ‘Gate 공핍층’의 두께가 변하기도 하지요. 이를 ‘공핍층 Modulation’이라고 합니다.
확산 공핍층과 바이어스 공핍층(Bias)의 상관관계
지난 장에서 다룬 두 개의 공핍층(▶해당 글 보러 가기)은 확산 공핍층이라 할 수 있습니다. 이는 외부에서 인가되는 전압 없이 화학접합면(Js, Jd)에서 확산에너지에 의해 자연히 형성되는 층입니다. Source와 Drain 불순물 농도만 같으면, 두 공핍층은 서로 대칭이며 동일한 두께를 갖습니다.
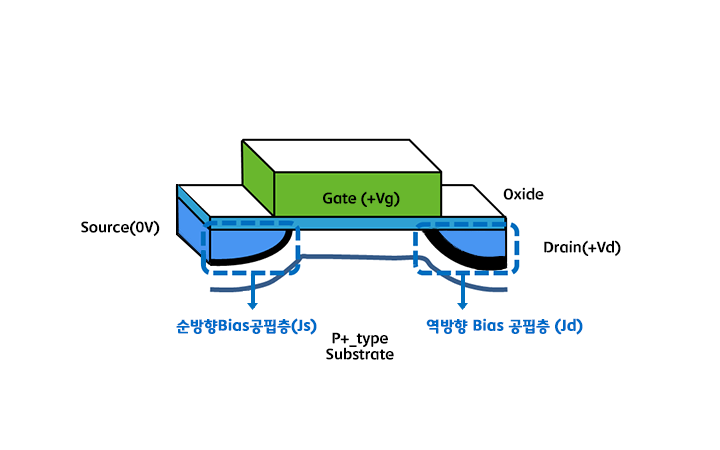
▲ 확산 공핍층에 외부 Drain전압이 전달될 때, 만들어지는 바이어스 공핍층(순방향공핍층/역방향공핍층)
Gate단자에 +전압이 인가된 상태를 유지하면서, Source단자에 0V, Drain단자에 +전압(+Vd)을 가해봅시다. (트랜지스터가 정상적으로 Switching동작을 하는 조건) 그러면 Drain단자의 +전압으로 인해 확산 공핍층 두 군데 모두 두께가 변하는데요. 바이어스전압 때문에 공핍층의 두께가 변했기에 이를 ‘바이어스 공핍층(Bias)’이라고 하겠습니다. Source Junction(Js)에서 바이어스 공핍층은 원래 확산방식으로 형성된 공핍층보다 공핍영역이 좁아지고(순방향 바이어스 공핍층), Drain Junction(Jd)에서의 바이어스 공핍층은 공핍영역이 더욱 넓어집니다(역방향 바이어스 공핍층)
순방향 Bias공핍층
순방향/역방향의 기준은 다수 캐리어가 정상 혹은 반대로 흐르느냐로 결정합니다. 다수 캐리어가 Junction을 가로질러 정상으로 흐를 때 ‘순방향 바이어스 공핍층’이라 하고, 반대 방향으로 움직일 때 형성된 공핍층을 ‘역방향 바이어스 공핍층’이라고 합니다.
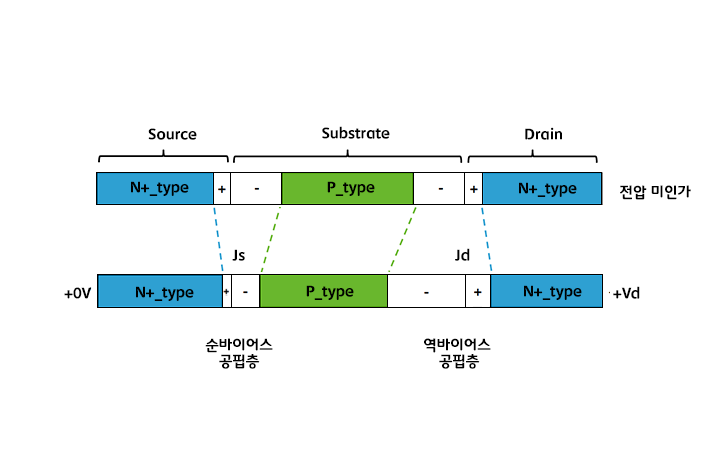
▲ 순방향과 역방향으로 전압 인가시의 공핍층의 변화
자세히 말하면, Source Junction(Js)을 가운데 두고 전계에너지와 확산에너지가 평형상태에 있는 확산 공핍층에 순방향 바이어스 전압을 걸면, 균형이 무너지며 전계에너지가 확산에너지보다 증가하지요. 그에 따라 Source단자에 있는 다수 캐리어인 전자들이 Drain단자의 +전압을 향해 대거 이동합니다. 그러면서 +로 대전된 Donor이온(Source단자)의 많은 hole을 메우게 되지요. 마찬가지로 Js의 P_sub side에 형성된 공핍층에도 P_sub의 다수 캐리어인 hole이 달려들어 확산 방식으로 형성된 공핍층 두께를 절반 가까이 줄게 합니다. 이때 흐르는 다수 캐리어인 전자와 hole의 개수는, 순수반도체일 때 실리콘(섭씨 25도)에서 빠져나오는 것에 비해 1억 배~100억 배(1x 10^18 ~10^20 개) 가까이 됩니다.
역방향 Bias공핍층
반면, Drain단자에 같은 전압을 인가할 때, Drain Junction(Jd) 양쪽에 형성된 공핍층에는 Js 양쪽 공핍층과 반대현상이 발생합니다. Drain단자에 인가된 +전압이 Drain단자내의 전자를 잡아당기고 P_sub단자내의 hole을 밀어내기에, 확산방식으로 형성된 공핍층 두께가 Jd를 기준으로 해서 양쪽으로 더욱 넓어집니다.
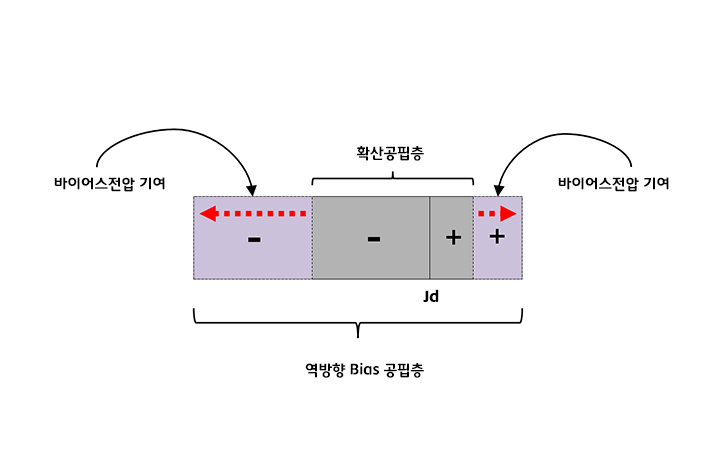
▲ 역방향 Bias공핍층 영역을 형성하는 바이어스전압의 기여 부분
Drain공핍층 두께가 생성되는 과정을 보면, Jd의 Drain단자에 1차로 형성된 확산 공핍층은 P_sub단자에 있던 다수 캐리어인 hole이 Jd을 넘어와 형성한 공핍층(+Donor)입니다. 2차로 넓어지는 역방향 공핍층은 Drain단자 자체 내의 다수 캐리어인 전자가 중성상태의 N+_type단자에서 빠지며 만든 공핍층(+Donor)입니다. 공핍층 중에는 역방향 Drain공핍층이 순방향 Source공핍층 보다 트랜지스터 동작에 더욱 큰 영향을 끼칩니다. 공핍층 두께도 몇 배 더 넓지요.
결국, 역방향 공핍층에서는 Jd를 넘는 다수 캐리어는 사라지고, 소수 캐리어(전자, hole)만 Drain Junction을 지납니다. P타입의 소수 캐리어 전자가 N+_type Source단자에서 넘어온 다수 캐리어인 전자와 합쳐, MOSFET을 흐르는 대전류가 돼 Switching작용의 주인공이 됩니다.
다수 캐리어와 소수 캐리어와의 관계
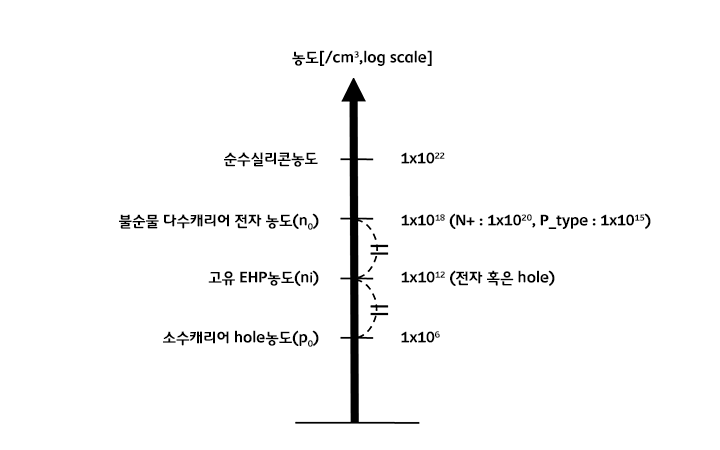
▲ 다수 캐리어 전자농도와 소수 캐리어 hole농도의 예
다수 캐리어의 원천이 불순물 원소(Doping을 하는 Dopant)인 반면, 소수 캐리어의 원천은 순수실리콘 원소에서 발생한 고유 캐리어인 전자 혹은 정공입니다. 예를 들어, ‘순수실리콘 반도체(Intrinsic Silicon)’는 순수실리콘농도가 ㎤당 약 10^22 개 일 경우, 상온에서 전자-정공 Pair(EHP)로 약 1×10^10 ~ 10^12개(농도와 온도 변수) 정도는 수시로 발생합니다. 실리콘원자가 전자를 다시 포획해 EPH를 소멸시키기도 합니다. 그때 5(15)족 원소를 고유반도체 실리콘농도 대비 1백분의 1배 정도로 해서 순수실리콘(4족)에 도핑시킵니다. 그러면, N+_type의 전자 약 1×10^20개 정도가 5(15)족 원소 속에 있다가 뛰어나올 준비를 합니다. 전자가 탈출하기 전까지는 N+_type불순물은 중성 상태입니다.
그 후 외부에서 알맞은 전위(순수실리콘 원소에서 전자를 떼어내는 데 소모되는 에너지의 20분의 1)를 가하면 N+_type불순물 원자 내 전자들은 다수 캐리어(약 1×10^18 ~ 10^20개)가 돼 움직입니다. 이때 고유반도체에서 생성된 EHP중 전자는 다수 캐리어인 전자들의 엄청난 숫자(약 1십억 배)에 묻히지요. 정공은 다수 캐리어(전자)에 의해서 소멸해 상쇄된 숫자를 제외하고, 살아남은 정공들이 다수 캐리어를 피해 다니며 소수 캐리어로 활동합니다. 따라서 소수 캐리어(예:정공 농도p0) 숫자는 순수EHP 개수(예:전자 농도 또는 정공 농도 ni)를 넘지 못하며, 불순물 다수 캐리어 농도(전자 농도:n0)에 반비례하게 됩니다.
ni2 = n0 * p0 p0는 불순물원소의 다수 캐리어 전자(도너 불순물 원자농도 Nd) + 순수실리콘의 정공이 결합한 후 최종적으로 남은 소수 캐리어 hole농도
공핍층을 만드는 에너지
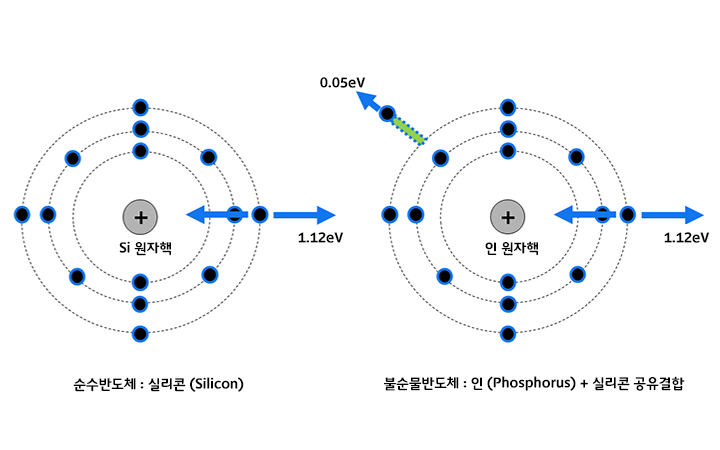
▲ 5족-4족 공유결합 후의 잉여전자와 순수실리콘 최외각전자가 탈출하는데 소모되는 에너지 비교
불순물 반도체의 장점은 트랜지스터를 동작하는 에너지 소모가 적다는 것이지요. 같은 전자라도 불순물 반도체로부터 잉여전자를 떼어내는 에너지(도너 혹은 억셉터 원자의 이온화 에너지 : 약 0.05eV)가 순수 실리콘 반도체로부터 최외각전자를 탈출시키는 에너지(실리콘 밴드갭 에너지: 1.12eV) 보다 약 이십 분의 1배 정도로 작게 소요됩니다. 매우 작은 에너지로도 불순물 중성원자를 이온화시킬 수 있기 때문에, 반도체 제조공정을 꿈의 연금술이라 할 수 있겠습니다. 확산 공핍층과 바이어스 공핍층을 쉽게 만들고 이를 기반으로 Drain단자에 가하는 전압을 낮춰, 더 낮은 전력을 소모하는 친환경 반도체도 가능해집니다.
우리가 사용하는 반도체는 불순물을 조금만 첨가해도 공핍영역이 변화하고 전도율을 향상시킬 수 있습니다. 결국 OFF 상태의 반도체를 ON 상태로 쉽게 바꾸는 장점이 있다는 말이지요. 위에서 언급한 숫자와 변화들은 단순한 숫자와 변화가 아니라 반도체가 성장하고 있다는 것을 의미합니다. 우리가 성장하는 동안 소통하고 모습도 변하는 것처럼 말이죠. 다음 장은 이번 장과 연결된 Channel에 대해 이어갑니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.



