
반도체 칩을 만들 때에는 막을 쌓는 일부터 시작하는데요. 칩 내의 트랜지스터가 ON/OFF 전기적 신호를 빠른 속도로 처리하려면 막 두께를 얇고 균일하게, 시간 변수에도 손상되지 않고 오래 버틸 수 있도록 만들어져야 합니다. 막을 형성하는 방법으로는 증착(Deposition), SOG(Spin On Glass), 전해도금(Electro Plating) 등이 있는데, 이중에서 가장 많이 쓰이는 증착은 크게는 물리적 방식과 화학적 방식으로 나뉩니다. 현재 반도체 공정에서는 화학적 방식인 CVD를 많이 사용하고 있는데요. 이는 물리적 방식인 PVD보다 웨이퍼 표면 접착력이 10배 높고, 대부분의 막이나 표면에 적용 가능하므로 활용도가 높기 때문이지요. 이번 장에서는 CVD 방식 중에서도 많이 보편화되어 있는 저압CVD(LPCVD)와 고밀도플라즈마 증착(HDPCVD) 등을 중심으로 살펴보도록 하겠습니다. ▲<PVD, 전자가 이동하는 도로를 만들다> / <ALD, 원자를 이용해 박막을 만드는 방법> 편 참조
CVD 방식의 종류
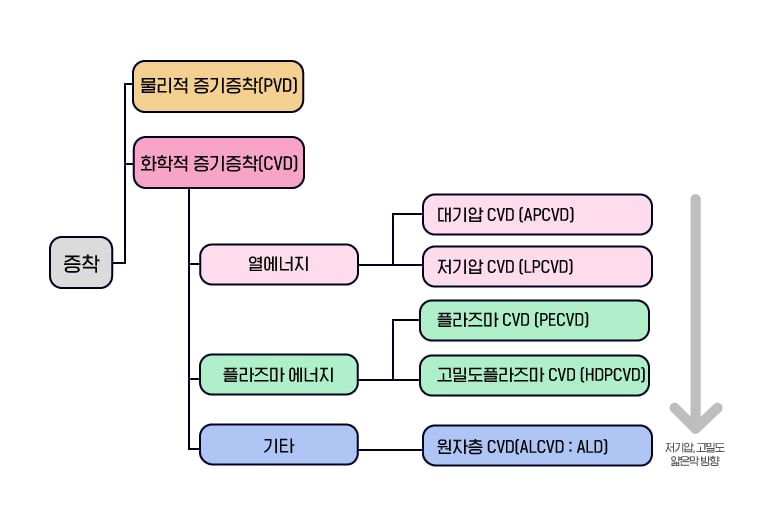
▲ CVD 방식의 종류
증착(Deposition)은 반도체 공정 중에서도 가장 다양한 방식으로 이루어져 있습니다. 증착막을 만들 때에는 증기(Vapor)를 이용하는데, 대표적인 방법으로 물리적 기상증착방법(PVD, Physical Vapor Deposition)과 화학적 기상증착방법(CVD, Chemical Vapor Deposition)이 있습니다. 이번 편에서 살펴볼 CVD는 프로세스 챔버 속 원료기체의 원소가 화학적으로 다른 원소로 변하면서 웨이퍼 표면에 달라붙어 증착하는 방법입니다. CVD는 가장 오래된 반도체 공정 중 하나로써, 긴 역사만큼 많은 진화를 거쳐왔다고 볼 수 있는데요. 열에너지를 이용한 방식으로는 APCVD(대기압 Atmosphere pressure CVD)와 LPCVD(저기압 Low Pressure CVD)가 있고, 플라즈마 에너지를 이용한 방식으로는 PECVD(저밀도 플라즈마)와 HDPCVD(고밀도 플라즈마)가 있습니다. 최근에는 원자를 표면에 흡착시키는 방식으로 한층 한층씩 쌓아 올리는 원자층 증착방법(ALCVD)을 많이 적용하는 추세입니다.
CVD의 세 가지 요소

▲ CVD의 공정 3요소
CVD공정의 핵심요소로는 진공압력, 온도 및 화학적 원소의 가스 농도이고, 챔버를 제어하는 요소로는 진공압력(+부피변화)과 온도라고 할 수 있습니다.
챔버 내부에 불필요한 기체가 없어야 하므로, 진공도를 높일수록 고품질의 막이 생성됩니다(현재 대기압 하의 APCVD는 막질이 떨어지므로 거의 사용하지 않음). 고(高)진공일수록 원하는 챔버 내로 투입된 두 가지 기체의 움직임(Mobility)도 저하되므로, 이를 높이기 위해 온도를 상승시킵니다(LPCVD 조건은 10Torr+섭씨 800도~1,000도). 기체의 모빌리티는 경계면에서 발생하는 화학반응 속도에 비례하므로, 이는 막의 성장 속도와 직결되는 중요한 요소가 됩니다. 하지만 온도를 높이면 챔버 내 모든 영역과 웨이퍼의 온도 또한 상승하므로, 기존에 증착된 웨이퍼 상의 금속막은 녹거나 형태가 변형되며 특성이 나빠집니다. 고진공 하에 온도를 높이지 않고 기체의 모빌리티를 높게 유지할 수 있는 방안으로 개발된 것이 바로 플라즈마 CVD이지요. 온도가 높아질수록 챔버 벽(Chamber Wall)의 온도도 함께 상승해야 챔버 내 온도가 일정해므로 웨이퍼 표면의 온도 편차가 줄어듭니다. 당연히 웨이퍼 상의 온도 편차는 막의 두께의 균일성(Uniformity)과 직결되겠지요. 또한, 투입된 기체의 농도가 높을수록 막의 품질이 향상(막의 단위 입방체 당 입자수가 높아짐)된답니다.
진공을 만든다
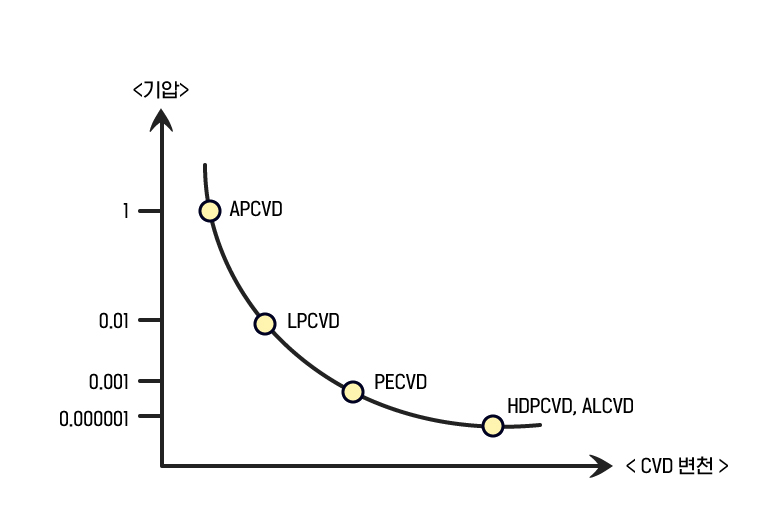
▲ 압력을 기준으로 본 CVD
여러 증착 방식 중, 열에너지를 기반으로 하는 CVD는 초기에 대기압(APCVD) 상태부터 진행되었습니다. 이후 대기압의 절반 정도 수준인 준기압(SACVD: Semi-APCVD)을 적용했다가, 최종적으로 프로세스 챔버 내 기압을 대기압의 약 10분의 1배 ~ 100분의 1배 정도까지 낮추게 되었지요(LPCVD).
웨이퍼를 챔버에 투입하고 CVD를 진행할 타깃 기체를 투입하기 전에, 챔버 내부의 진공을 높이면 불필요한 기체 입자들이 제거되므로 타깃 기체 분자의 평균자유행로(Mean Free Path, MFP)가 높아져 웨이퍼 표면의 화학적 CVD 반응이 활발해집니다. 이는 막의 두께 증가 속도의 향상으로 이어져 공정시간이 단축된다는 의미이지요. MFP가 높아질 경우 단차의 균일성 즉 단차의 피복성(Step Coverage)이 약화된다는 단점이 있습니다. 반대로 진공도가 떨어져 MFP가 낮으면 단차의 코너 위치(어깨)에서 Overhang(너무 많이 증착되어 막의 두께가 필요 이상으로 증가해 균일성이 떨어짐) 현상이 나타납니다. 이를 해결하기 위해 MFP를 적정하게 유지(진공도+입자 질량 및 크기 등 고려)하고, 온도를 상승시켜 막을 형성하고 있는 입자들의 막 내 이동도(Surface Mobility, 표면이동도)를 높이게 되면, 증착된 막의 두께가 좀 더 균일해집니다. 따라서 정밀하고 균일한 필름(얇은 막)을 만들 수 있게 되지요.
온도를 높인다, 그러나 높일 수 없다
▲ 온도를 기준으로 본 CVD 증착막
두 종류 이상의 원료기체 원소들을 결합시켜 증착막을 만들려면 많은 에너지가 투입되어야 합니다. 열에너지를 이용한 CVD는 압력이 낮아질 때 증착률이 감소하므로, 웨이퍼 온도를 높여 화학적 반응을 활발하게 합니다(APCVD에서 LPCVD 방식으로 가면서 압력을 100분의 1배로 줄이는 반면, 온도를 2배로 증가시킵니다. 그렇다고 LPCVD가 APCVD보다 증착 속도가 빨라지는 것은 아니지만, 진공으로 고품질의 막질을 얻을 수 있다는 장점이 있습니다). Poly Gate막 혹은 Gate Oxide 절연막과 같은 하부막은 그 밑에 별다른 막이 없으므로 LPCVD를 진행하면서 웨이퍼 온도를 섭씨 1,000도 가까이 높여도 하부에 녹는 막이 없습니다. 하지만 IMD(Inter-Metal Dielectric)층 같은 트랜지스터 상부에 위치한 막을 LPCVD의 온도(섭씨 1,000도)로 진행할 경우, 그 밑에 있는 메탈층(Word Line)이 녹아 내리는 불상사가 발생합니다. 따라서 낮은 온도에서도 단차피복성과 막의 균일성 등을 LPCVD와 비슷하게 형성할 수 있도록 플라즈마CVD(PECVD)가 개발되었습니다. PECVD는 열에너지를 적게 사용하는 대신 플라즈마 에너지를 보충하여 증착시키는 방식입니다.
플라즈마 증착(PECVD)
메탈층이 2~3개였던 1980년대 초반까지 만 해도 집적도가 낮았기 때문에 메탈 상부의 절연막을 형성하는데 APCVD 등을 적용할 수 있었습니다. CD가 높았기 때문에 낮은 온도에서도 다소 거친 막질로 메탈층을 보호할 수 있었지요. 하지만 구조가 복잡해지면서 특히 하부막으로 메탈층(재질로는 알루미늄, 구리 등)이 여러 개 늘어났으며, 또 메탈과 메탈 사이 간격이 좁아져 절연 기능이 향상된 절연막(IMD)으로 채워주어야 합니다. 이 경우 하부막인 메탈이 녹지 않도록 혹은 특성이 변하지 않도록 반드시 저온 공정인 PECVD(Plasma Enhanced CVD)나 HDPCVD를 적용해야 합니다. 상부에 위치한 Passivation 보호막을 증착 할 때도 마찬가지입니다.
PECVD는 플라즈마를 만들 때 생성된 여러 가지 입자(양이온, 음이온, 전자, 라디칼 등) 중 반응이 활발한 라디칼(Radical, 활성종)을 이용합니다. CVD 챔버에 두 종류의 가스를 주입한 후, 외부에서 RF 전원을 가하거나 높은 전위차(DC) 혹은 MW(Micro-Wave)를 인가해 플라즈마 입자들을 만들고, 용량성결합플라즈마(Capacitively Coupled Plasma, CCP) 방식을 이용해 이들을 웨이퍼 표면으로 모여들게 하지요. 이들은 에너지적으로 볼 때 매우 불안정하여 저온(섭씨 약 400도)에서도 다른 원소와 화학적으로 쉽게 결합하는데요. 저온임에도 불구하고 반응속도가 높아서 증착 속도는 빠르지만, 막질 상태가 좋지 않고 낮은 Step Coverage가 발생한다는 단점이 있습니다. 따라서 PECVD는 막의 품질이 좀 떨어져도 무방한 위치(Layer)에만 한정적으로 사용합니다.
고밀도플라즈마 증착(HDPCVD)
이러한 PECVD의 단점을 보완하기 위해 개발된 것이 바로 고밀도플라즈마(HDPCVD)입니다. 증착 속도는 PECVD보다 느리지만 치밀한 막질을 얻을 수 있는 방법이지요. 챔버 내는 백만 분의 1기압 정도로 유지합니다. 증착하면서 발생되는 스퍼터(Sputter)식각 시에 아르곤 이온의 직진성을 확보해주면 증착할 공간이 충분히 확보됩니다. 이렇게 되면 증착 후에 형성되는 증착막 내의 void도 거의 생기지 않게 됩니다. 이는 트랜치 혹은 Gap을 채우는 데에도 탁월한 효과가 있어서 SOG(Spin On Glass)를 대체할 뿐 아니라, 최근에는 PECVD의 대부분이 HDPCVD로 바뀌어가는 추세입니다.
웨이퍼 형태를 변형시키는 Fab 공정 중, 증착은 가장 변수가 많고 다양한 방법을 활용할 수 있는 공정입니다. 그만큼 노하우가 많이 쌓여있어 우리나라의 가장 경쟁력 있는 공정 중 하나이기도 하지요. 특히 오늘 살펴본 CVD는 트랜지스터 막을 구성하는 데 있어 비약적인 발전을 이룬 기술입니다. 현재 개발된 어느 공정보다도 가장 얇고 순도 높은 막을 어떠한 형태로든 균일하게 생성해낼 수 있지요. 따라서 향후, 다양성과 발전 가능성이 매우 높은 공정이라고 볼 수 있습니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.