차세대 메모리 셀 소자의 채널 물질 중 하나로 최근 각광받고 있는 비정질(Amorphous)* InGaZnO*(이하 a-IGZO) 기반 박막 트랜지스터*는 매우 낮은 누설전류(Off Current, Ioff)와 높은 전자 이동도*의 특성을 가지고 있다. 하지만 이러한 장점에도 불구하고 메모리 공정에서 일반적으로 진행되는 550°C 이상의 열이력*과 수소가 풍부한 공정들을 거친 a-IGZO 소자에 관한 연구는 활발히 수행되지 않았으며, 특히 a-IGZO가 해당 공정 조건 하에서 수소 관련 결함으로 인한 불안정 문제를 겪는 것으로 알려져 있기 때문에 관련된 연구가 필요한 시점이다.
이에 SK하이닉스는 2023 VLSI(Very Large-Scale Integration, 세계 3대 반도체 학회 중 하나) 심포지엄에서 결정질(Crystalline)* IGZO(이하 c-IGZO) 박막 트랜지스터에 대한 연구를 발표했다. 메모리 반도체 공정 과정인, 고온과 수소가 풍부한 공정에서 기존 a-IGZO 박막 트랜지스터와 특성을 비교한 것이다.
* 비정질(Amorphous, Non-Crystalline, 非晶質): 고체 물질로, 균일한 조성은 가지고 있으나 분자가 무작위로 배열되어 규칙이 없는 상태로 단결정, 다결정 등과 함께 분자 결정의 종류 중 하나를 뜻한다.
* InGaZnO(IGZO): 전자 이동도를 증가시키는 역할의 인듐(In), 전원 Off 시 누설전류를 방지하는 갈륨(Ga), 화합물의 화학적 구조를 안정화하는 아연(Zn), 산소 공공 조절을 통해 전자 밀도를 결정하는 산소(O)가 일정한 비율로 구성된 화합물. 이는 박막 트랜지스터의 활성층으로 사용된다.
* 박막 트랜지스터(Thin Film Transistor, TFT): 채널이 생성되는 활성층이 박막(Flim)의 형태로 기판 위에 형성되는 트랜지스터로서 전통적으로 LCD(액정 디스플레이)에 사용됐다.
* 전자 이동도(Electron Mobility): 반도체에서 전자가 전기장 내에서 얼마나 빨리 움직이는지 나타내는 정도
* 열이력: 지정된 온도 제한을 초과하지 않고 장치 내에서 태워져 흩어지거나 허용될 수 있는 열에너지 또는 열의 총량
* 결정질(Crystalline, 結晶質): 물질을 구성하는 원자나 이온들이 규칙적으로 배열된 물질
c-IGZO의 열 안정성 및 수소 공정 저항성 입증
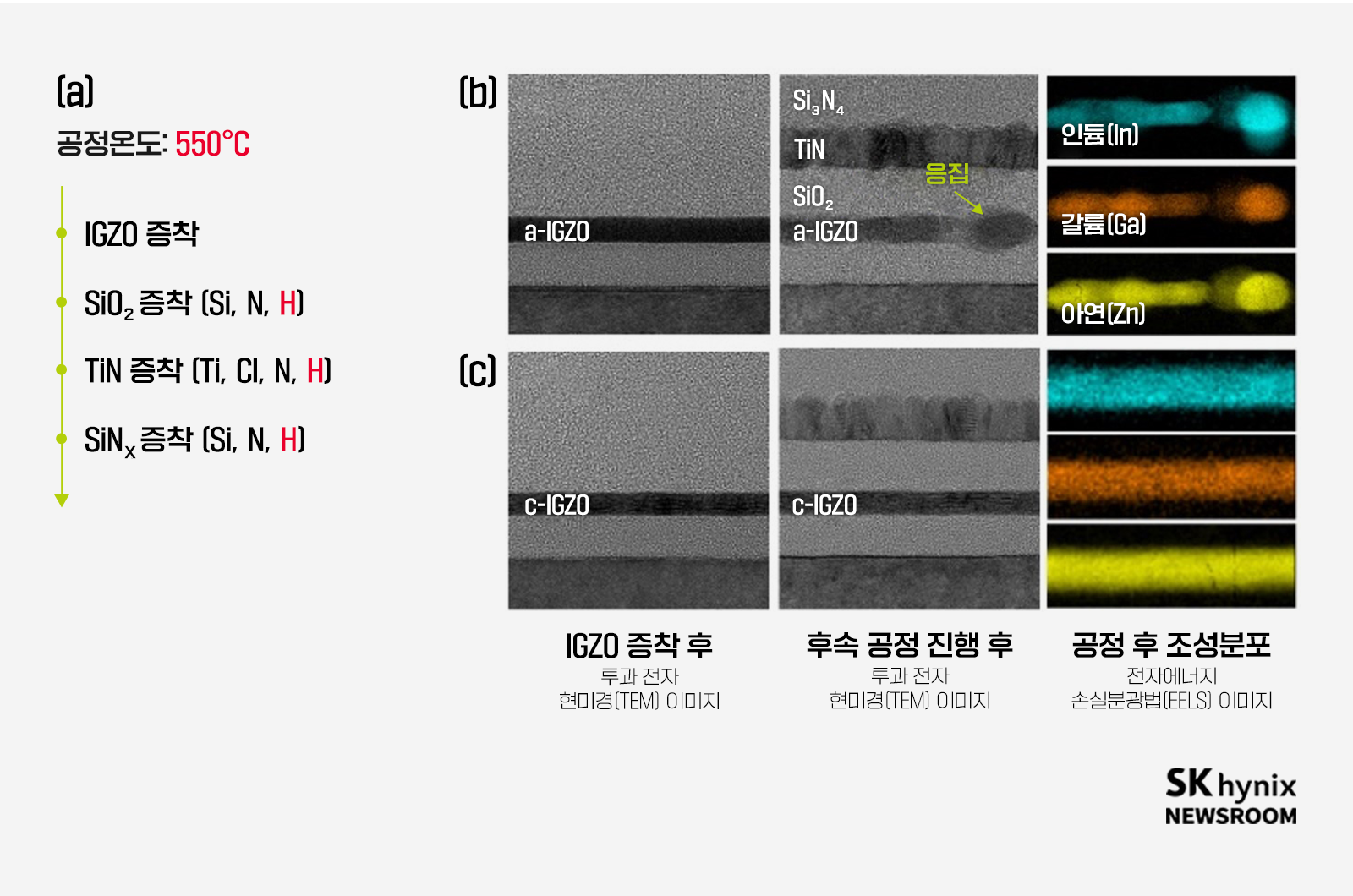
▲ 그림 1: (a) IGZO 증착 후 공정 온도 550°C에서 수소가 포함된 다양한 공정 (b) a-IGZO 증착 후, 후속 공정 진행 후의 모습을 보이는 투과 전자 현미경(TEM) 이미지와 후속 공정 진행 후의 조성분포를 보여주는 전자에너지 손실분광법(EELS) 이미지 (c) c-IGZO 증착 후, 후속 공정 진행 후의 모습을 보이는 투과 전자 현미경(TEM) 이미지와 후속 공정 진행 후의 조성분포를 보여주는 전자에너지 손실분광법(EELS) 이미지

▲ 그림 2: (a) a-IGZO와 c-IGZO TFTs(A-D)의 전달 특성. 드레인 전압(Vds) 1V(W/L=0.8/0.1 마이크로미터 [μm])에서 갈륨(Ga)의 농도가 A에서 D까지 점차 증가한다. (b) 다양한 IGZO 조건에서 문턱전압(Vth)과 온–전류**(게이트 전압[Vgs]-문턱전압[Vth]=3V에서의 드레인 전류[Ids])에 대한 성능 비교
** 온-전류(On-Current): 소스와 드레인 사이에 전류를 흐르게 하기 위해 문턱전압 이상의 전압을 인가한 상태
<그림 1>의 (b), (c)에 나타난 바와 같이 수소가 풍부한 고온의 증착 공정을 여러 차례 거친 후 a-IGZO에서는 응집*이 관찰된 반면, c-IGZO는 구조적 변화 없이 안정성을 유지했다. 이는 c-IGZO가 a-IGZO와 비교해 고온에서 수소에 대한 내성이 훨씬 더 강하며, 이로 인해 소자 성능 개선을 위한 추가적인 게이트 산화물 두께(Tox) 스케일링이 가능할 수 있음을 의미한다. 한편, <그림 2>의 (b)에서는 c-IGZO(A~D)의 조성을 조절하여 문턱전압(Vth)을 제어할 수 있음을 보여준다. c-IGZO(C)의 문턱전압(Vth)은 a-IGZO와 유사했지만, c-IGZO(C)의 온-전류(Ion)는 a-IGZO(A’)보다 1.8배 더 높았다.
* 응집(Agglomeration): 입자나 과립이 서로 엉겨 붙어 더 큰 클러스터나 덩어리가 형성되는 과정
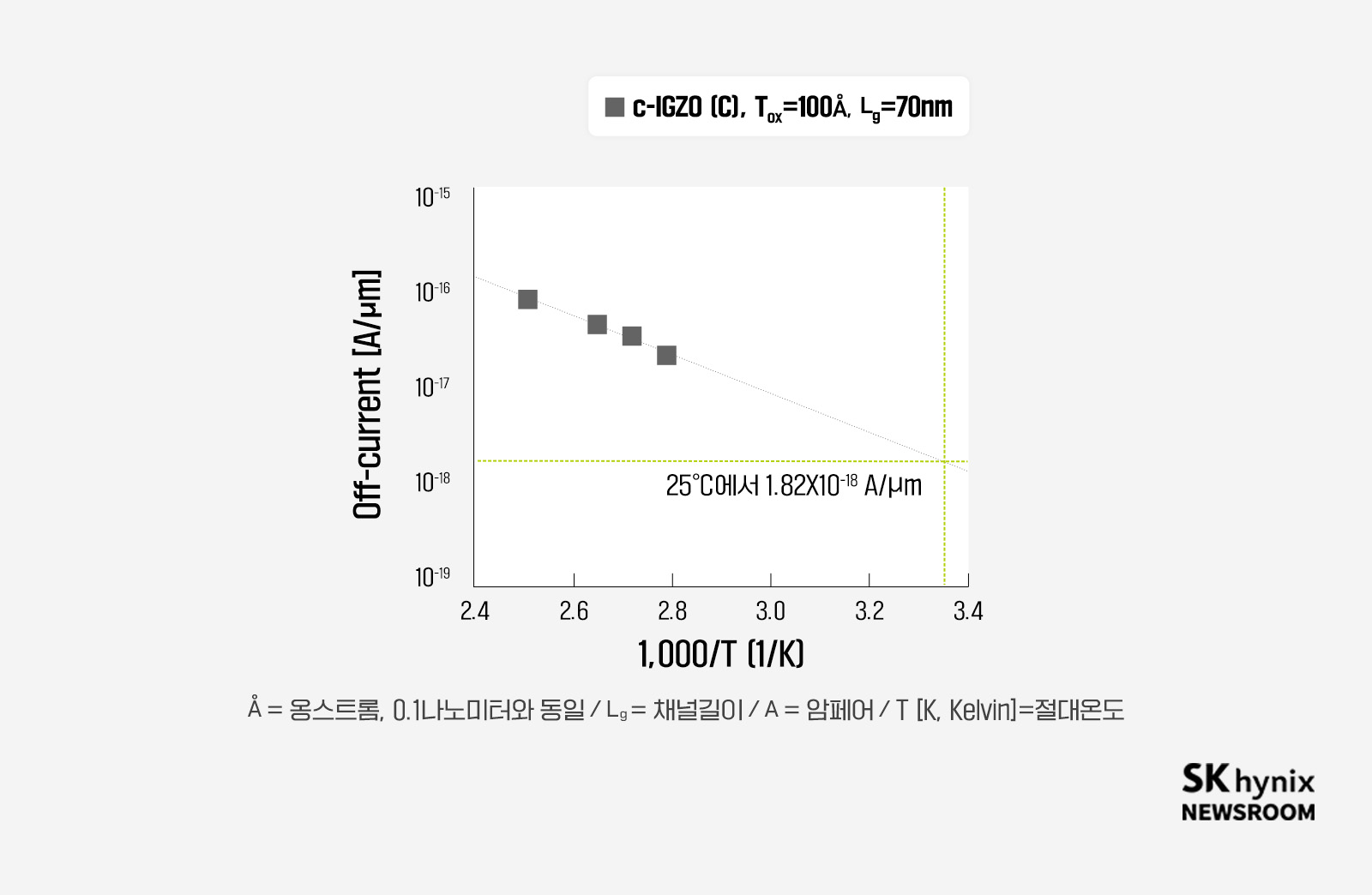
▲ 그림 3: 아레니우스 플롯(Arrhenius Plot)에서 추출한 채널 길이 70nm의 c-IGZO(C) TFT의 25°C에서 오프-전류
<그림 3>은 채널 길이*(Lg)가 70나노미터(nm)인 c-IGZO 박막 트랜지스터에서의 오프-전류(Ioff)는 1.82×10−18 A/마이크로미터(μm)로, 매우 낮은 수준임을 보여준다. 이는 c-IGZO가 긴 데이터 보존 시간을 가질 수 있기 때문에, D램 셀 소자의 채널 재료로 활용 가능하다는 것을 시사한다.
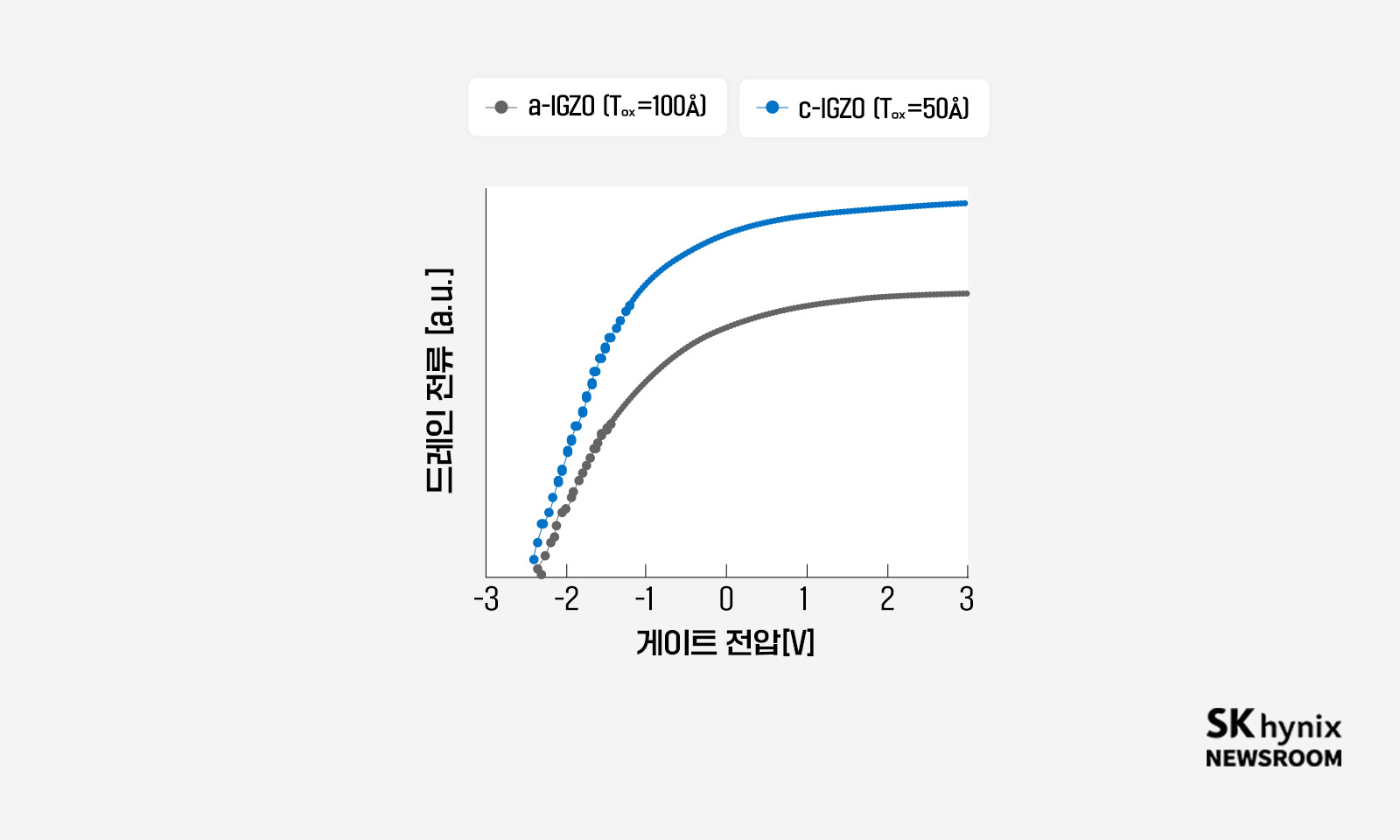
▲ 그림 4: a-IGZO(Tox=100Å)와 최적화된 c-IGZO(Tox= 50Å)의 트랜지스터 IV 특성(Vds = 1V)
또, <그림 4>에서 연구원들은 조성 제어 및 게이트 산화물 두께(Tox) 조정을 통해 최적화된 c-IGZO가 문턱전압 이하 스윙*과 온-전류(Ion)에서 상당한 수준으로 개선된 모습을 보여주었다.

▲ 그림 5. 최적화된 c-IGZO(Tox =50Å) TFT의 포지티브 바이어스 온도 스트레스(PBTS) 1,000초 전후 비교
그리고 <그림 5>에서 알 수 있듯, 최적화된 c-IGZO 박막 트랜지스터는 상대적으로 얇은 게이트 산화물 두께(50Å)에도 불구하고, 포지티브 바이어스 온도 스트레스(PBTS)* 테스트 후 측정 결과 a-IGZO(+19mV)와 유사한 문턱전압 변화(ΔVth)를 보였다. 이는 c-IGZO가 a-IGZO에 비해 문턱전압(Vth) 안정성이 더 우수함을 의미한다.
* 채널 길이(Channel Length, Lg): 소스와 드레인 단자 사이의 반도체 채널 길이를 나타내는 금속 산화막 반도체 전계효과 트랜지스터(MOSFET)의 임계치수
* 문턱전압 이하 스윙: 전류를 10배 변화시키는 데 필요한 전압 변화량(Vgs)
* 포지티브 바이어스 온도 스트레스(Positive Bias Temperature Stress, PBTS): 반도체 장치의 신뢰성 테스트. 게이트 단자에 포지티브 바이어스 전압을 인가해 장치를 높은 온도에 노출시킨다.
c-IGZO: 차세대 메모리 채널 재료의 유망주
연구진은 c-IGZO가 a-IGZO에 비해 우수한 열 안정성과 수소 공정 저항성 덕분에 메모리 공정 후에도 소자의 성능과 문턱전압(Vth) 안정성을 개선할 수 있다는 사실을 발견했다. 이러한 특성을 갖춘 c-IGZO는 고온 공정이 요구되는 미래 메모리 장치에 사용할 새로운 소재 중 하나로 주목받고 있다.
RTC에서 진행하고 있는 연구에 대한 인사이트는 Research Website(research.skhynix.com)에서 더 많은 정보를 찾을 수 있다.



