
반도체의 크기가 줄어들고 저장 용량이 커질수록 전자를 어느 곳에 보관하고, 어떻게 이동시킬 것인지가 점점 중요한 이슈로 부각되고 있습니다. 전자가 지나가는 도선이나 전자를 담는 그릇 그 자체는 도체의 기능을 갖는 성분입니다. 하지만 전자의 이동 통로를 확보하거나 전자의 이동을 막아내는 것은 산화막 이나 질화막 같은 절연체가 합니다. 이렇듯 서로 반대 기능을 갖는 물질과 형태들을 적절히 배분하는 기술이 마스킹(Masking)과 절연 기술인데요. 이러한 기능은 얇은 두께를 갖는 막을 이용해 실현합니다. 오늘은 반도체에서 쓰이는 산화막(이산화실리콘 혹은 실리카 Silica)과 다른 절연층을 비교하면서 이런 막들을 어떻게 형성시키는지에 대해 알아보도록 하겠습니다.
산화막과 질화막의 기능
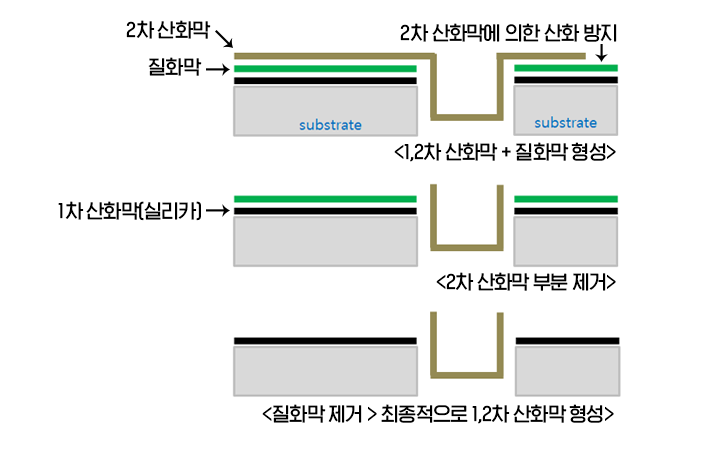
▲ 산화막(SiO2)과 보조 기능을 하는 질화막
반도체에서 널리 활용되는 절연막은 다양한 목적에 따라 여러 가지가 있지만, 크게 산화막과 질화막으로 나누어 알아보겠습니다. 산화막(Oxide)은 말 그대로 산소가 결합해 형성한 막이고, 질화막은 당연히 질소가 결합한 것인데요. 최근에는 산화막이나 질화막에서 파생되어 발전된 여러 가지의 절연막이 다채롭게 활용되고 있습니다.
산소 형성을 위한 케미컬로는 산소 가스 혹은 물분자를 사용하며, 최근에는 플라즈마를 이용하기도 합니다. 질화막 형성을 위해서도 질소 가스 혹은 플라즈마를 사용합니다. 질화막 보다는 산화막이 보다 강력한 절연 기능을 갖고 있기 때문에, 절연막으로서는 산화막을 주로 사용하고, 질화막은 대부분 보조 역할을 합니다. 질화막은 ‘1차 산화막+질화막+2차 산화막(O-N-O 절연막)’의 구조처럼 산화막과 산화막 사이에 형성합니다. 또, 어떤 경우에는 산화막의 여러 종류를 만드는 과정에서 1차 산화막(SiO2) 위에 추가적인 2차 산화막(1차 산화막 입장에서는 2차 산화막도 공정 불순물입니다)으로 인한 영향을 막기 위해 Fab공정상 잠시 사용했다가 제거하기도 합니다. (‘NAND Flash Memory 동작특성’ 참조)
절연층 용도와 위치
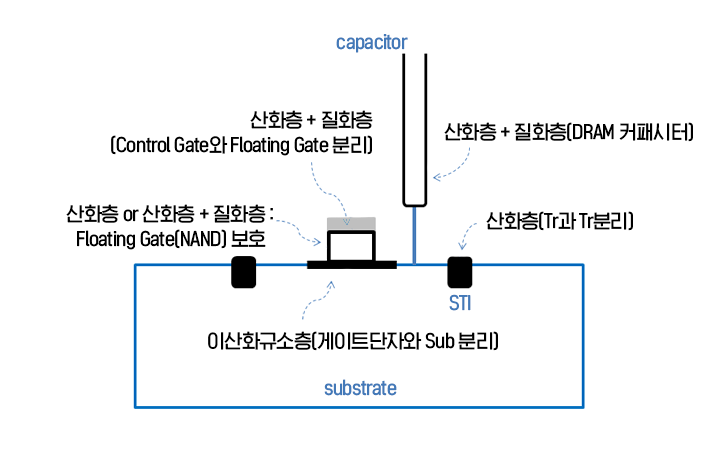
▲ 절연층의 위치 @ DRAM과 NAND의 복합 형태의 예
그럼 절연층이 반도체 어디에 있는지 살펴볼까요? 절연층은 아주 다양하게 사용되는 만큼 또 여러 군데에 적용되는데요. 가장 기본적으로는 Tr과 Tr을 구분하기 위하여 담벼락으로 사용합니다. 또, 게이트 단자 밑에 집어넣어서 소스-드레인간에 터널이 가능하도록 하고, 커패시터 내에 전자를 가두어 놓기 위해 높은 성벽으로 둘러치기도 하지요. 도선을 만들 때 역시 다른 도선과 연결되지 않도록 도선과 도선 사이에 끼워 넣습니다. 물론 외부로부터 반도체를 보호하기 위해 이불처럼 반도체 회로 전체를 덮는 용도로 사용되기도 합니다.
절연층 형성 방식

▲ 산화방식과 절연층 증착방식의 비교
절연층을 형성하는 방식은 변수에 따라 종류가 다양합니다. 예전에는 고전적인 방식인 산화방식이 가장 높은 절연 상태를 만들기 때문에 제일 중요한 곳인 게이트 밑에 게이트 옥사이드 층을 두었습니다. 하지만 최근에는 게이트 절연층을 형성하는 방식도 다변화하고 있습니다.
온도 변수로는 가스와 액체 모두 높은 온도를 이용한 산화-고열방식이 있습니다. 또, 증착(Deposition)방식은 온도변수, 압력변수, 플라즈마 변수 그 외에 원자 Level 변수도 활용하고 있습니다. 산화방식은 기판 속으로(아래쪽으로) 산화가 확산되면서 동시에 기판 위로도 산화물질이 쌓여지는 방식이고요. 증착은 기판 표면에서 위쪽 방향으로만 쌓아 올리는 방식입니다.
산화막의 건식과 습식 비교
산소나 질소와 같이 가스를 사용하는 경우는 액체가 없으므로 건식(Dry 방식)이라고 하고, 물 같은 액체를 사용하는 경우는 습식(Wet 방식)이라고 합니다. 예전에는 절연층 중에서 가장 중요한 게이트 옥사이드(산화막 중 게이트 밑에 위치하는 산화막)는 보통 건식 산화막으로 진행했습니다. 일반적으로 건식 절연막은 얇고 절연도가 높기 때문에 중요한 곳에 사용하는 반면, 습식은 두껍고 중요도가 떨어지는 층으로 공정 중에 임시 사용하는 마스킹 용도나 외부 영향 차단용인 제품 보호막(Passivation층)으로 사용했지요.
그러나 건식 산화막은 고품질이지만, 습식에 비해 공정 진행 속도가 습식의 20% 혹은 10% 정도로 매우 느립니다. 산화막 형성 속도는 기판의 상태나 산화를 진행하는 조건에 따라 영향을 많이 받습니다. 따라서 게이트 옥사이드층도 빠른 습식 방식을 적용하면서 습식의 단점인 낮은 절연성을 보완하는 방식을 사용하기도 합니다. 실리콘은 높은 온도에서 산소를 만나면 이산화실리콘이 되고, 물을 만나면 이산화실리콘과 수소 분자가 나오는데요. 습식일 경우, 이산화실리콘은 실리콘에 달라붙게 되고, 그와 동시에 발생된 수소가스는 배출하면 됩니다.

▲ 산화막의 건식과 습식의 비교(모두 높은 열을 가하는 방식으로 사용)
산화공정뿐 아니라 식각공정, 세정공정 등 다른 반도체 공정에서도 역시 건식과 습식이 사용되고 있는데요. 모든 공정이 다 그런 것은 아니지만, 건식공정은 대부분 시간이 오래 걸리거나 복잡한 대신 결과물의 수준이 높습니다. 반면 습식방식은 건식공정에 비해 비교적 쉬우며 단기간에 수행되지만 품질 상태는 떨어진답니다. 건식이든 습식이든 낮은 온도에서는 진행 속도가 떨어지므로 열을 높게 가해 되도록 빠르게 공정이 진행되도록 하는 추세입니다. 온도와 압력, 진공도까지 높아지면서 반도체 장비 가격은 천정부지로 치솟고 있는데요. 이런 것들이 바로 반도체 장비의 국산화율을 높여야 하는 이유이기도 합니다.
절연기능(유전율)
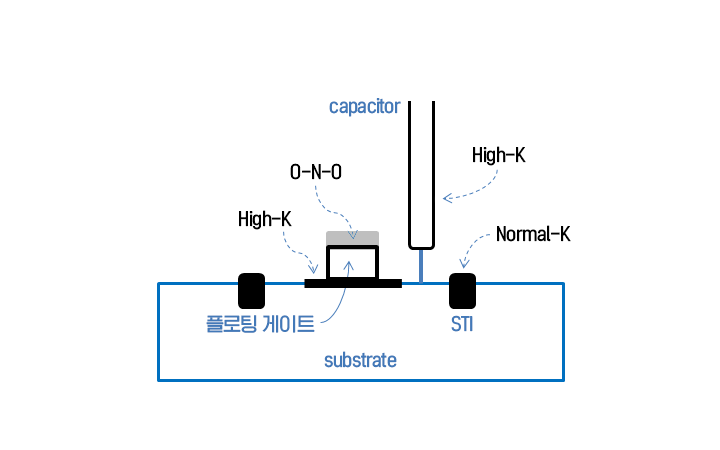
▲ 유전율과 절연층
절연막에서 중요한 것은 어떤 용도로 쓰이느냐에 따라 절연성을 높이기도 하고 낮추기도 한다는 것입니다. 예를 들어 전자를 많이 저장할수록 좋은 기능을 하는 커패시터를 둘러 싼 절연체는 높은 절연 기능을 가진, 유전율이 높은(High-k, 여기서 k는 유전율을 의미) 물질을 씁니다. 그러나 소자의 동작속도를 높여야 하는 도선 사이에서는 도선 사이의 폭이 갈수록 좁아지므로 낮은 절연 기능인 유전율이 낮은(Low-k) 물질을 사용하는 빈도수가 높아지지요. 물론 High-k와 Low-k사이의 일반적인 층은 중간 정도의 유전율 값을 갖는 층을 사용하지요.
유전율은 마법 상자와 같아서 어떤 곳에서는 전자를 많이 모아야 하는 데 사용하고, 또다른 곳에서는 동작속도를 감안하여 유전율은 낮고 절연기능 만을 높이기도 합니다. 이렇게 여러 가지를 감안하다 보면 복잡해지니, 절연체는 일반적으로는 유전율이 보통인 것을 사용한다고 보면 되지만, 유전율이 아주 높거나 아주 낮은 것을 점점 많이 사용하는 추세이지요. 낮은 유전율은 디바이스의 동작속도를 높이고 전력을 적게 쓰기 때문입니다. 그리고 일부 특수한 곳인 D램의 커패시터나 NAND Flash의 플로팅 게이트를 둘러쌓는 벽은 동작 속도나 전력 사용량 보다는 전자의 이동을 막아야 하는 게 급선무이므로 High-k 물질을 적용한다고 생각하면 편합니다. 유전율 k값이 클수록 커패시터나 플로팅 게이트가 차지하는 부피를 줄일 수 있기 때문입니다.
이번 장에서는 절연기능 중 산화막에 대해 알아보았습니다. 회로 상에서의 절연기능은 반도체의 도전기능 못지 않게 중요한 기능입니다. 전자를 이동하거나 보관할 때는 반드시 다른 전자와의 상호 연락을 차단하고 전자를 보호해야 하므로, 차단 역시 도통 만큼이나 큰 의미를 갖죠. 실제 Fab공정상에서도 도체 보다는 알맞은 부도체를 만드는 것이 더 어렵기도 하고요. 실리카(실리콘산화막)는 매우 양호한 부도체 역할을 해내고, Fab 공정 진행 중에는 필요하지 않은 다른 원소들의 확산을 굳건하게 차단시켜주는 보호막 역할을 톡톡히 해냅니다. 실리카(이산화실리콘, SiO2)는 전자의 이동을 막는 데 있어 인간이 만든 가장 이상적인 절연막이라고 해도 과언이 아니죠. 다음 장에서는 산화막(Oxide층)을 형성할 때의 증착과 확산작용에 대해 좀 더 자세히 살펴보도록 하겠습니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.



