패키지를 봉합하는 ‘인캡슐레이션(Encapsulation) 공정’은 반도체 칩을 외부 환경으로부터 보호하기 위해 특정 물질로 감싸주는 단계입니다. 패키지가 지향하는 ‘경박단소(輕薄短小, 가볍고 얇고 짧고 작음)’의 외형을 비로소 드러내는 단계이기도 하지요. 인캡슐레이션 공정은 크게 세라믹 판 혹은 금속 뚜껑을 붙여 봉합하는 허메틱(Hermetic) 방식과 플라스틱 재질의 에폭시(Epoxy) 물질을 녹인 후 경화시켜 봉합하는 몰딩(Molding) 방식이 있습니다. 그 중 허메틱 방식은 현재 거의 쓰이지 않고, 99% 이상이 EMC(Epoxy Molding Compound)를 사용한 몰딩 방식을 사용하고 있지요. 몰딩 공정은 반도체에 수지(Resin)를 채우는 방법에 따라 다시 트랜스퍼 몰딩(Transfer Molding)과 컴프레션 몰딩(Compression Molding)으로 나뉩니다. 오늘은 인캡슐레이션 공정에 대해 간단히 살펴보고, 몰딩 방식을 중심으로 자세히 알아보도록 하겠습니다.
※ 봉합, 밀봉, 밀폐 등은 서로 뜻이 비슷한데, 본고에서는 봉합(Encapsulation)은 보다 큰 범주로 보고, 밀봉은 몰딩(Molding)으로 한정하여 사용하도록 하겠습니다.
1. 봉합재(Encapsulant)에 따른 패키지 인캡슐레이션(Encapsulation) 방식
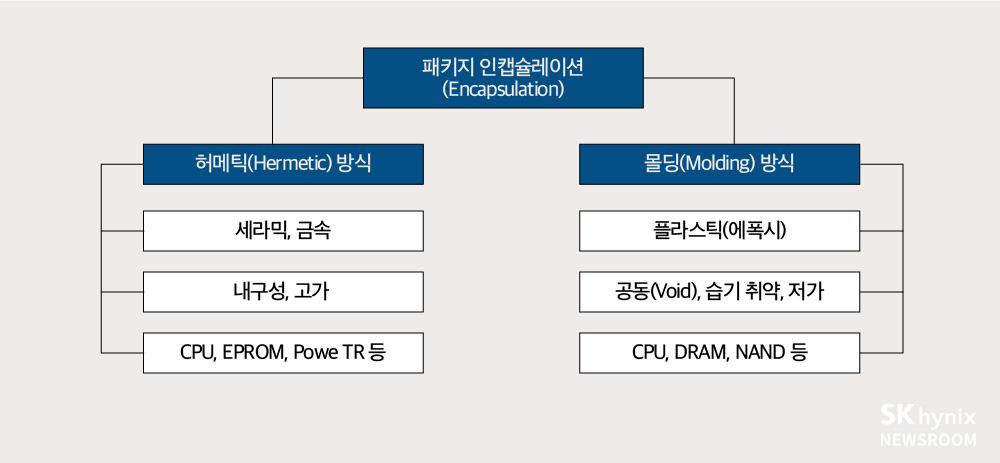
<그림1> 허메틱(Hermetic) 방식과 몰딩(Molding) 방식의 비교
세라믹(Ceramic)이나 금속을 이용한 허메틱(Hermetic) 방식의 패키지는 내구성이 좋고 수명이 길다는 장점이 있습니다. 이러한 이유로 국방, 의료 등 특수 분야의 기기에 주로 적용되지요. 대표적인 제품군으로는 CPU, EPROM(Erasable Programmable Read Only Memory, 비휘발성 반도체 기억장치), Power TR(전력용으로서 사용되는 대출력 트랜지스터) 등이 있습니다.
그러나 허메틱 방식을 적용할 경우 신뢰도가 높은 대신 고가이기 때문에, 현재는 플라스틱 재질의 에폭시(Epoxy) 물질을 쓰는 몰딩(Molding) 방식을 많이 사용하고 있습니다. 플라스틱의 경우 습기 및 내부 공동(Void) 등의 불량 현상을 꾸준히 개선해 사용범위를 급속히 확대해나가고 있습니다. EPROM부터는 거의 99.9%를 플라스틱 재료로 봉합하기 시작해 DRAM, CPU, NAND 등 거의 모든 패키지에 적용되고 있지요.
허메틱 방식은 공장에서 미리 제작한 콘크리트 판넬을 아파트 외벽에 붙이는 방식이라면, 몰딩 방식은 건설 현장에서 직접 거푸집을 만들어 콘크리트를 타설하는 방식이라고 이해할 수 있습니다. 몰딩 방식의 경우 유연성이 향상된 방식이지만, 콘크리트 속에 기공이 발생할 가능성이 허메틱 방식보다 높습니다.
2. 몰딩 재료: EMC(Epoxy Molding Compound)
반도체 후공정에 필요한 필수 기능성 재료 중 하나인 EMC(Epoxy Molding Compound)는 플라스틱의 일종으로, 수지라는 레진(Resin) 계통의 물질이 주류를 이룹니다. 그 외에 필러(Filler)와 경화제가 섞여 있습니다. 분말(Compound) 상태인 에폭시는 175℃의 온도에서 젤 상태로 녹이면 용융되며 점성이 낮아집니다. 이후 온도를 낮추면 에폭시가 경화되면서 점성이 온도와 반비례하며 높아지기 시작하지요. 이때 온도를 더욱 낮추면 에폭시는 주변의 PCB(Printed Circuit Board)나 리드프레임(Lead Frame), 와이어, 웨이퍼 등과 강한 결합력을 나타내며 매우 높은 경도의 물질이 됩니다. 이를 열경화성 에폭시라고 합니다. 경화된 후의 EMC는 반도체가 동작 시 온도가 오르내릴 때 칩과 유사하게 팽창 및 수축을 유지하도록 조절하는 것이 중요하며, 온도를 외부로 빼내는 작용이 중요합니다. 따라서 혼합재의 특성이 EMC의 신뢰성을 결정하게 됩니다.
3. 몰딩(Molding) 공정의 종류

<그림2> 몰딩(Molding) 공정: 트랜스퍼 몰딩(Transfer Molding)과 컴프레션 몰딩(Compression Molding)
몰드(Mold)란 어떠한 모양으로 성형한다는 것을 의미합니다. 반도체를 성형(Molding)할 때는 EMC를 녹여 캐비티(Cavity, 금형(金型)에 주입합니다. 몰딩을 담당하는 기계인 몰더(Molder)의 핵심은 금형판입니다. 몰딩의 방식으로는 오래된 방법인 트랜스퍼 몰딩(Transfer Molding)과 트랜스퍼 몰딩의 단점을 보완하며 발전된 방식인 진공 몰딩 그리고 웨이퍼를 수직으로 하강(Face Down)시켜 진행하는 컴프레션 몰딩(Compression Molding) 등이 있습니다.
3-1. 트랜스퍼 몰딩(Transfer Molding)
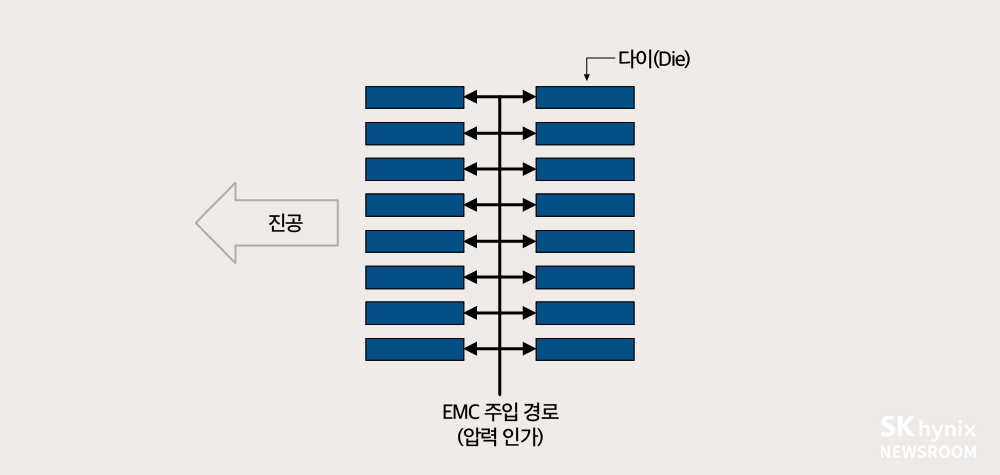
<그림3> 트랜스퍼 몰딩(Transfer Molding)
트랜스퍼 몰딩은 수지를 이용한 방식으로, 몰딩의 초기 방식이라고 할 수 있습니다. 에폭시를 젤 상태로 녹인 뒤 일정 압력(Plunging)을 강제로 인가해 복수의 좁은 통로로 이동하게 하는 방식이지요. 하지만 칩이 소형화 및 다층화되고 와이어본딩(Wire Bonding)의 구조가 더욱 복잡해짐에 따라, 몰딩 시 에폭시가 골고루 퍼지지 못해 불완전한 성형이 되거나 공동, 다공(Prosity)의 발생이 증가했습니다. 즉 에폭시의 속도 조절이 힘들어진 것이지요.
이 문제를 해결하기 위해 에폭시를 좁은 통로로 이동시킬 경우, 반대편에서 진공을 만들어 뽑아내는 방식을 사용해 에폭시의 속도를 조절하고 있습니다. 또, 에폭시가 골고루 구석구석 퍼질 수 있도록 해 공동을 줄이는 노력을 하고 있습니다.
3-2. 컴프레션 몰딩(Compression Molding)
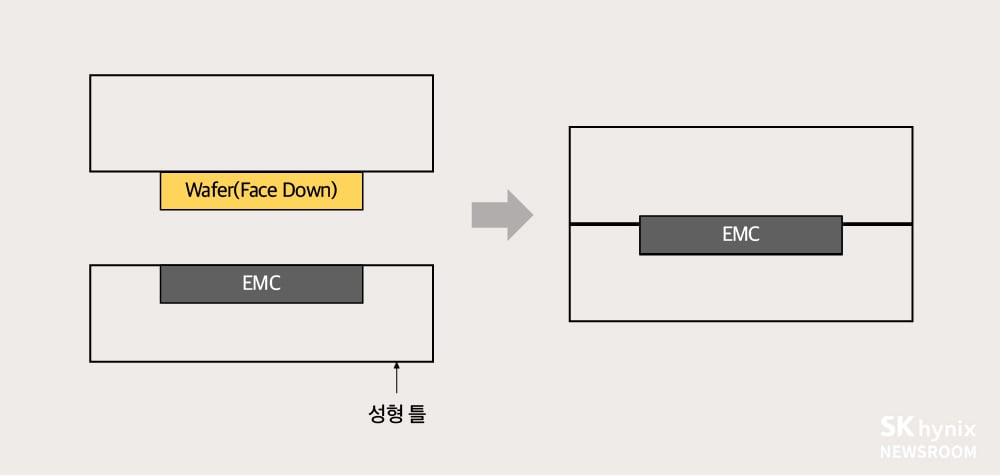
<그림4> 컴프레션 몰딩(Compression Molding)
트랜스퍼 몰딩은 칩의 단수가 높아지고(Multi Chip Package, MCP) 와이어본딩이 복잡해지면서 점차 한계를 드러내게 됩니다. 특히 원가 절감 측면으로 캐리어(PCB 혹은 리드프레임)의 대형화로 인해 트랜스퍼 몰딩은 더욱 어려워졌습니다. 이와 함께 에폭시가 복잡한 구조를 뚫고 멀리 퍼져나가는 데 어려움이 있어 새로운 방식이 필요했지요.
컴프레션 몰딩은 트랜스퍼 몰딩의 한계를 극복한 새로운 방식으로, EMC를 먼저 틀 안에 넣고 용융시키는 방식입니다. 컴프레션 몰딩을 적용할 경우 에폭시를 멀리 전달시킬 필요가 없게 되었지요. 젤 상태의 에폭시 위에 웨이퍼를 수직 하강(Face Down)시켜 몰딩하는 방식입니다. 공동 및 스윕(Sweep) 현상 등의 불량을 줄이는 효과가 있으며, 불필요한 에폭시의 사용을 줄여 환경에도 긍정적이지요.
지금도 에폭시를 이용한 반도체 몰딩 방식으로 트랜스퍼 방식과 컴프레션 방식을 병행해 사용하고 있습니다. 컴프레션 방식의 경우 공급자 입장에서는 불량 감지, 원가 절감, 환경 영향 최소화 등의 장점으로 선호도가 높습니다. 제품의 평탄화 및 박형화에 대한 고객의 니즈가 증가하고 있는 만큼, 앞으로도 컴프레션 방식은 더욱 활발하게 사용될 것으로 예상됩니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.



