패턴을 만드는 공정으로는 포토(Photo), 식각(Etching), 세정(Cleaning) 등이 있습니다. 그중 식각공정은 포토(Photo)공정 후 감광막(Photo Resist, PR)이 없는 하부막 부분을 제거해 필요한 패턴만을 남기는 단계입니다. 마스크(Mask) 패턴이 PR로 코팅된 웨이퍼에 내려온 후(노광→현상), PR 패턴이 다시 PR 하부에 형성된 막으로 이동되는 과정이지요. 회로 선폭(Critical Dimension, CD)이 미세화(2D 관점)됨에 따라 식각 방식은 습식에서 건식으로 변화했고, 그에 따라 장비와 공정의 복잡도는 높아졌습니다. 식각공정은 3D 셀(Cell) 적층(Stack) 방식의 활성화로 핵심 성능지수에 변동이 생겼으며, 전반적으로 2D/3D 기술이 발전함에 따라 포토공정과 더불어 반도체 핵심공정으로 부상했습니다.
1. 증착과 식각의 기술 발전 트렌드
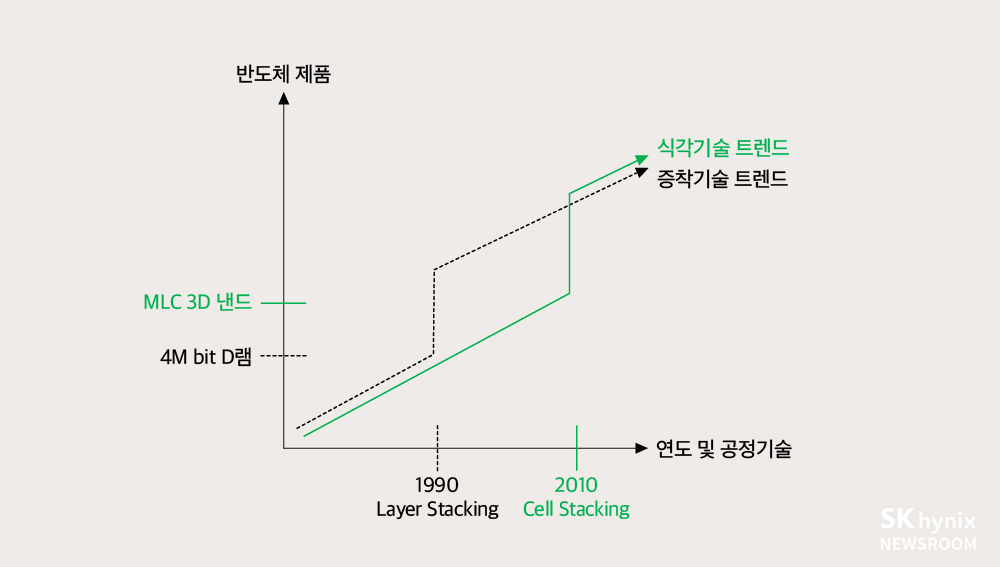
<그림1> 증착과 식각의 기술 발전 트렌드
웨이퍼에 막(Layer)을 형성하는 공정은 증착(Deposition: CVD, ALD, PVD), 형성된 막 위에 회로패턴을 그리는 공정은 노광(Exposure)이라고 합니다. 두 공정을 거친 뒤, 웨이퍼에 새겨진 패턴대로 조각을 하는 공정이 바로 식각(Etching)이지요. 포토(Photo)공정은 밑그림을 그리는 단계이므로, 웨이퍼에 실질적인 외형 변화를 일으키는 공정은 증착과 식각이라고 할 수 있습니다.
반도체가 탄생한 이후 현재에 이르기까지 식각과 증착 기술은 앞뒤를 다투며 발전해왔습니다. 증착에 있어 가장 획기적인 변곡점은, 1990년대 초 1Mb에서 4Mb D램으로 디바이스 용량이 확장되면서 트렌치(Trench)가 아닌 적층(Stack) 방식을 채용한 것입니다. 식각의 경우, 3D 낸드플래시 셀을 24단 이상으로 쌓기 시작했던 2010년대 초반이라고 할 수 있습니다. 그 후 현재까지 128단, 256단, 512단으로 셀을 적층해야 하므로 식각은 기술적으로 가장 난해한 공정 중 하나가 되어가고 있지요.
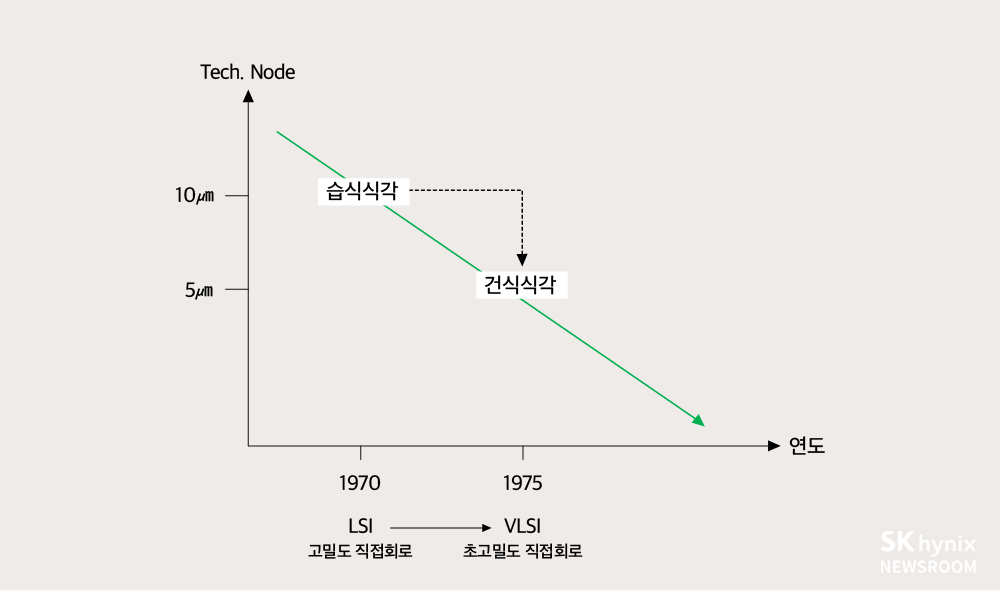
<그림2> 미세화(2D)에 따른 식각 방식의 발전
2. 식각 방식의 변천
식각공정은 2D(평면 구조) 반도체의 미세화 및 3D(입체 구조) 반도체의 적층 기술에 발맞춰 함께 발전해왔습니다. 2D 반도체가 주류를 이뤘던 1970년대에는 회로 선폭이 100㎛(마이크로미터)에서 10㎛, 10㎛ 이하급으로 급격히 줄어들던 시기였습니다. 이 시기에는 대부분의 반도체 핵심 공정 기술의 정렬이 마무리됐으며, 식각 기술도 습식식각(Wet Etch)에서 건식식각(Dry Etch)으로 정착되었지요. 막을 깎아내는 기술은 손쉬운 방식인 화학적 습식이 먼저 적용되었고, 1970년대 초 화학적 습식으로는 5㎛ 선폭을 구현할 수 없게 되자 플라즈마를 이용한 건식 방식이 새롭게 개발되었습니다. 오늘날 대부분의 식각공정은 건식으로 진행되고 있으며, 습식식각은 세정공정 쪽으로 응용 및 발전되었습니다.
3. 습식식각과 건식식각의 장단점

<그림3> 습식식각과 건식식각의 장단점
습식식각은 용액을 재료로 하는 만큼 건식에 비해 속도가 빠른(1분당 제거되는 깊이가 큰 식각률을 가짐) 반면, 식각 후 구조물이 네모반듯한 형태로 나오지는 않습니다. 모든 방향으로 동일하게 깎아내는 등방성의 성질을 갖고 있지요. 이러한 성질로 인해 습식식각은 횡적 방향으로의 면적 손실이 터부시되는 미세화에 있어 CD 조절에 치명적인 단점을 갖게 됩니다. 그러나 건식식각은 한쪽 방향으로만 식각을 하는 이방성의 성질(대부분 이방성+약간의 등방성)을 갖습니다. 증착막(Layer)을 수직축 아래로만 깎아내므로, 식각 후 의도했던 나노미터(nm) 단위 프로파일(Profile)의 초미세구조를 구현할 수 있는 수준까지 와있습니다.
또 습식식각은 공정 완료 후 사용한 액체를 폐기해야 하므로 환경오염을 야기하지만, 건식식각의 경우 배출 라인 중간에 스크러버(Scrubber)라는 장치를 통해 배기가스를 중화시켜 공기 중으로 배출하기 때문에 환경 영향이 적다는 장점이 있습니다.
한편, 웨이퍼 위는 여러 층이 복잡하게 얽혀있는 구조이므로 식각 시 필요한 층(막질)을 선택하는 데 있어 어려움이 따릅니다. 막질을 선택할 때는 화학적으로 반응하는 용액을 사용하는 습식식각이 유리하며, 건식식각은 물리적 방식과 화학적 방식을 합성시켜 깎는 방식이기 때문에 선택적 식각 측면에서는 불리하답니다.
4. 식각의 막질과 형태
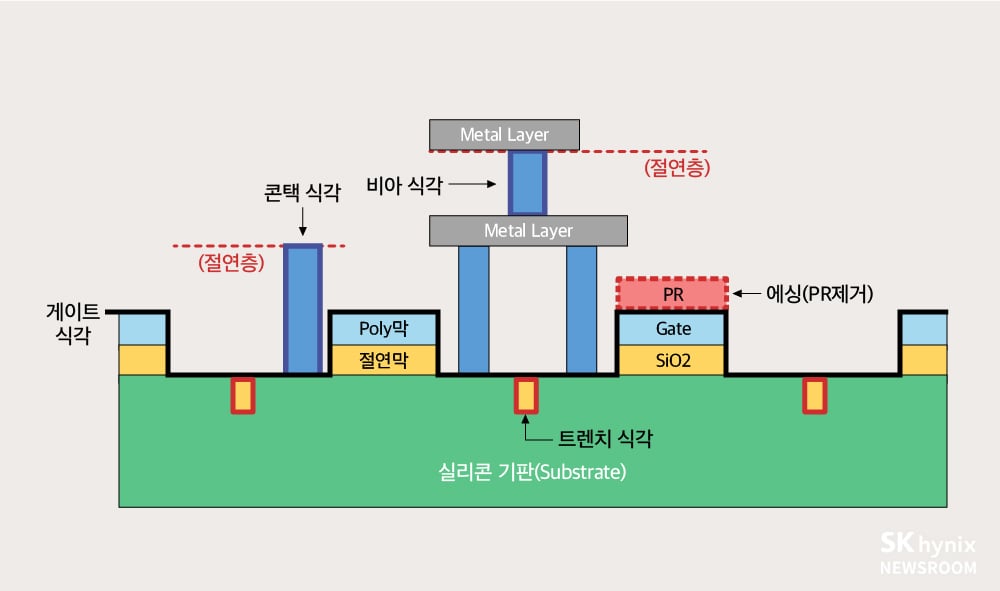
<그림4> 식각의 막질과 형태
막질의 측면에서 볼 때, 식각의 대상은 크게 전기가 통하는 도전성 막(Metal Layer를 깎는 것을 금속식각이라 함)과 전기가 통하지 않는 절연체 막으로 볼 수 있습니다. 그 외 실리콘에 불순물을 주입한 폴리(Poly)막이 있지요. 식각을 해야 할 하부 막질로는 대표적으로 절연막인 이산화실리콘(SiO2)막과 게이트 단자로 사용되는 폴리막이 있습니다. 게이트 단자 형성 시 건식식각을 진행할 경우 이 둘을 묶어 한꺼번에 식각하면 포토와 에싱(Ashing) 공정 스텝을 줄일 수 있습니다. 습식식각일 경우는 각 막질에 따라 알맞은 용액을 선택해 막별로 매번 식각을 하고 그에 따른 화학 반응을 면밀히 살펴야 합니다.
형태적 측면에서 식각이 기여하는 모습을 보면, 게이트 식각 이외에도 아래층과 위층을 연결하는 통로를 만들기 위한 콘택(Contact)/비아(Via)식각이 있고, Tr(Transistor)과 Tr 사이를 분리해주는 트렌치(STI용 Trench)식각이 있습니다. 콘택/비아 식각은 해당하는 절연막을 아래로 뚫고 그 구멍으로 도전성 물질을 채워 넣어 Tr 단자와 상단의 막을 연결하는 데 목적이 있습니다. 트렌치 식각은 참호처럼 실리콘 기판에 얇은 깊이로 구멍을 파낸 뒤 그곳에 강력한 절연성 물질을 채워 넣어 Tr과 Tr 사이에 누설 전류가 흐르지 못하도록 하지요.
5. 식각공정의 순서와 문제점
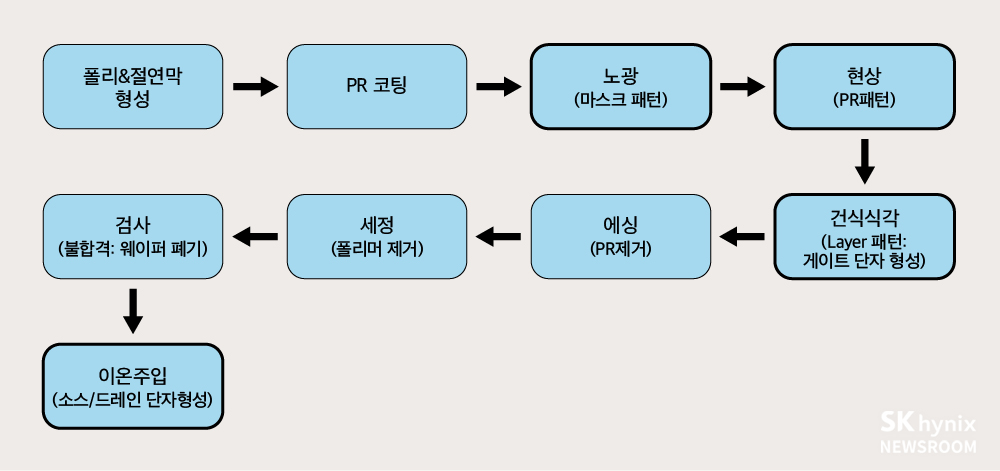
<그림5> 식각과 관련된 앞뒤 공정 순서
막을 형성하고 형성된 막 위에 PR을 도포한 뒤 노광 > 현상 > 식각 > 에싱 > 세정 > 검사 > 이온주입으로 이어지는 공정 스텝은 Tr 단자 3개를 만들어내는 반도체 핵심 공정입니다. 이때 PR을 깎아내는 현상(Develope)이 잘 이뤄지지 않을 경우 잔존해있는 PR이 식각을 방해합니다. 식각 시에도 패턴을 만들 때 타깃(Tartget) 막을 충분히 깎아내지 않으면(Under Etch) 이온주입 시 불순물 입자들이 막혀 계획한 대로 주입하지 못하게 됩니다. 건식식각 후 남아있는 폴리머 찌꺼기를 완전히 세정하지 못한 경우에도 마찬가지지요. 또 식각 시 플라즈마 이온 가스양이 많거나 시간 조절에 실패해 막을 과다하게 깎게 되면(Over Etch) 하부 막질에 물리적 손상이 생깁니다.
따라서 건식식각에서는 정확한 종말점(EOP: End of Point)을 찾는 게 중요하며, 식각 후 PR을 제거하는 에싱 및 세정공정과 더불어 식각 상태를 꼼꼼히 검사해야 합니다. 또한, 웨이퍼 내 부분별 식각률이 상이해도 일정 영역별 Over Etch와 Under Etch가 발생해 웨이퍼 자체가 Reject될 수 있습니다. 식각에 있어 Over Etch보다는 Under Etch가 더 치명적이라 할 수 있지요.
식각공정의 경우 복잡한 프로세스로 이뤄져 있는 만큼, 두 개의 챕터로 나눠 진행합니다. 이번 편에서는 식각의 발전 방향과 변천 등 식각공정을 이해하는 데 도움이 될만한 개략적인 내용을 살펴봤습니다. 다음 편에서는 좀 더 세밀한 내용에 대해 알아볼 텐데요, 플라즈마와 식각의 관계, 식각 방식인 RIE, 식각의 성능지수인 Aspect Ratio, 식각의 속도 등에 대해 다뤄보도록 하겠습니다.
※ 본 칼럼은 반도체/ICT에 관한 인사이트를 제공하는 외부 전문가 칼럼으로, SK하이닉스의 공식 입장과는 다를 수 있습니다.



