· 온디바이스 AI 구현 시 발생하는 발열 문제 해결 기여해 글로벌 고객사 높은 평가
· “소재 기술 혁신 통해 차세대 모바일 기기용 D램 시장 선도할 것”
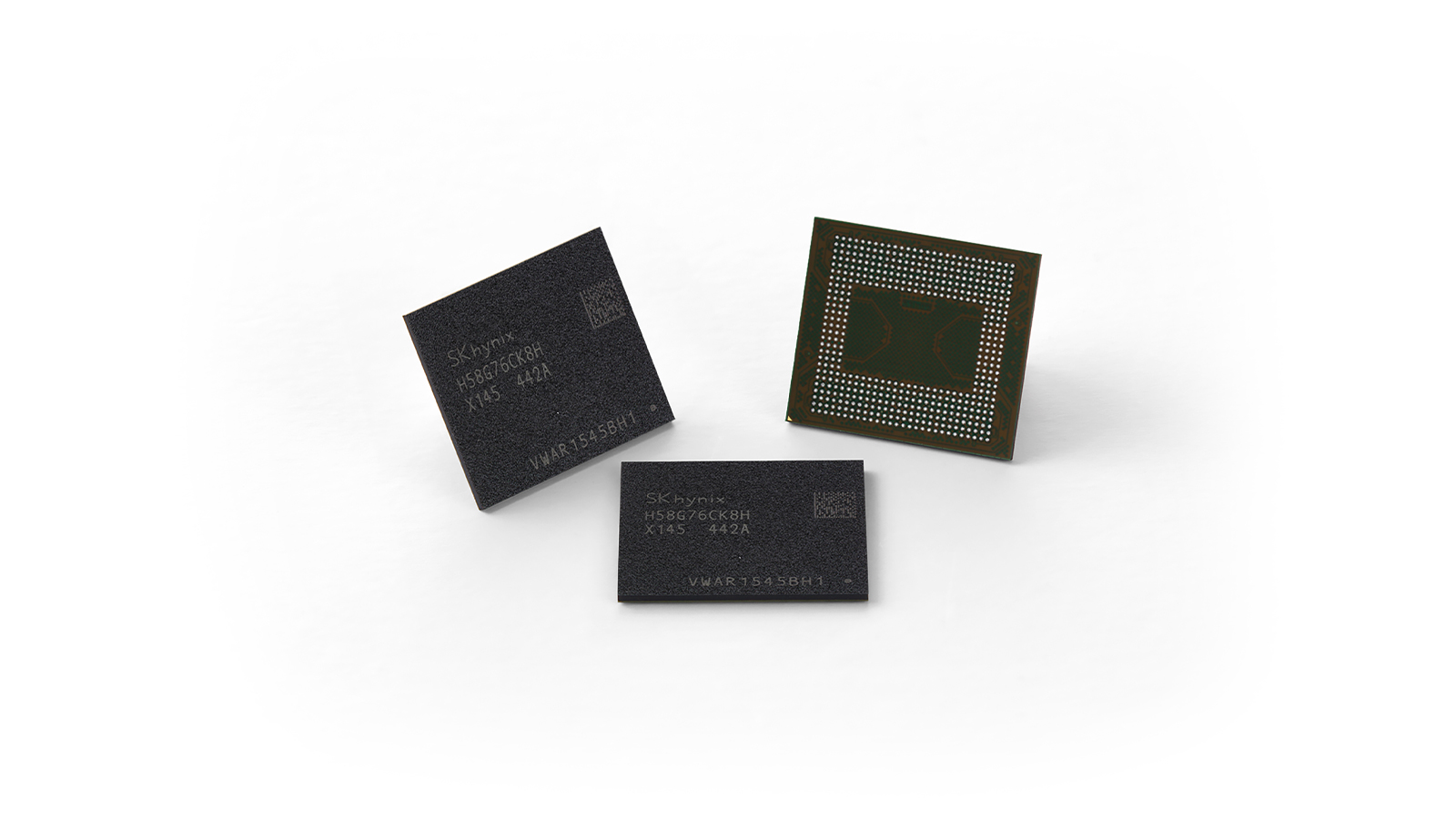
SK하이닉스가 업계 최초로 ‘High-K EMC(Epoxy Molding Compound)*’ 소재를 적용한 고방열 모바일 D램 제품을 개발해 고객사들에 공급을 개시했다고 28일 밝혔다.
* EMC(Epoxy Molding Compound): 수분, 열, 충격, 전하 등 다양한 외부 환경으로부터 반도체를 밀봉해 보호하고 열을 방출하는 통로 역할도 하는 반도체 후공정 필수 재료. High-K EMC는 열전도 계수(K)가 높은 물질을 EMC에 사용해 열전도도(Thermal conductivity)**를 높인 것을 뜻함
** 열전도도(Thermal conductivity): 물질이 열을 얼마나 잘 전달하는지를 나타내는 물리적 특성으로, 단위 시간 동안 특정 물질을 통해 얼마나 많은 열이 이동하는지를 뜻함
회사는 “온디바이스(On-Device) AI 구현을 위한 데이터 고속 처리 시 발생하는 발열이 스마트폰 성능 저하의 주요 원인이 되고 있다”며, “이번 제품으로 고사양 플래그십(Flagship) 스마트폰의 발열 문제를 해결해 글로벌 고객사들로부터 높은 평가를 받고 있다”고 밝혔다
최신 플래그십 스마트폰은 모바일 AP(Application Processor)* 위에 D램을 적층하는 PoP(Package on Package)** 방식을 적용하고 있다. 이 구조는 한정된 공간을 효율적으로 활용하고 데이터 처리 속도를 향상시키는 장점을 제공한다. 하지만 모바일 AP에서 발생한 열이 D램 내부에 누적되면서 전체적인 스마트폰 성능 저하도 함께 야기한다.
* 모바일 AP(Application Processor): 스마트폰, 태블릿 등 모바일 기기에서 두뇌 역할을 하는 반도체 칩. 연산, 그래픽, 디지털 신호처리 등 한 개의 칩에 완전 구동이 가능한 제품과 시스템이 들어 있는 시스템온칩(System on Chip, SoC) 형태의 중앙처리장치
** PoP(Package on Package): 모바일 제품에 많이 사용되는 대표적인 적층 패키지로, 각각 다른 종류의 반도체 패키지를 위아래로 쌓아 공간 효율, 성능 향상, 조합 유연성을 꾀하는 방식
SK하이닉스는 이 문제를 해결하기 위해 D램 패키지를 감싸는 핵심 소재인 EMC의 열전도 성능 향상에 주력했다. 기존에 EMC의 소재로 사용하던 실리카(Silica)에 알루미나(Alumina)를 혼합 적용한 신소재인 High-K EMC를 개발한 것이다.
이를 통해 열전도도를 기존 대비 3.5배 수준으로 대폭 향상시켰으며, 그 결과 열이 수직으로 이동하는 경로의 열 저항을 47% 개선하는 성과를 거뒀다.
향상된 방열 성능은 스마트폰의 성능 개선과 소비전력 절감을 통해 배터리 지속시간, 제품 수명 연장에도 기여한다. 이러한 효과로 모바일 업계에서 이 제품에 대한 관심과 수요가 높아질 것으로 전망된다.
SK하이닉스 이규제 부사장(PKG제품개발 담당)은 “이번 제품은 단순한 성능 향상을 넘어, 고성능 스마트폰 사용자들이 겪는 불편 해소에 기여한다는 점에서 큰 의미가 있다”며 “소재 기술 혁신을 바탕으로 차세대 모바일 D램 시장에서의 기술 리더십을 확고히 구축해 나가겠다”고 강조했다.