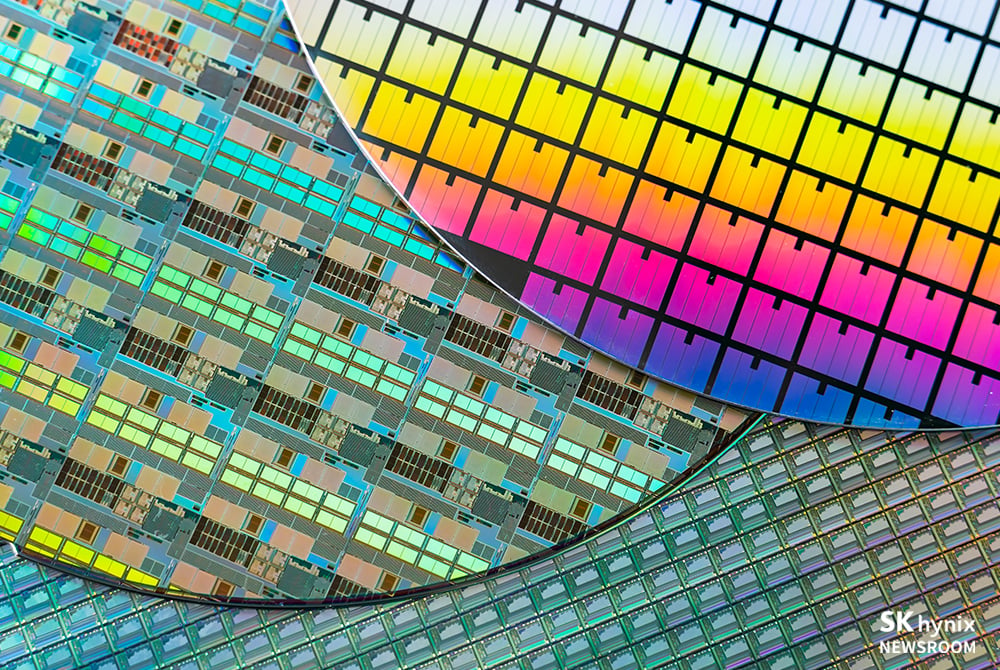
웨이퍼는 반도체 칩이 되기까지 세 번의 변화 과정을 거친다. 첫 번째 변화는 덩어리 상태의 잉곳(Ingot)이 슬라이스(Slice) 돼 웨이퍼가 되는 것이고, 두 번째는 전 공정을 통해 웨이퍼 전면에 트랜지스터가 새겨지는 것이다. 마지막으로 패키징(Packaging) 공정에서 웨이퍼가 개별 반도체 칩으로 나뉨으로써 비로소 반도체 칩이 된다. 후공정에 해당하는 패키지 제조 공정에서는 웨이퍼를 육면체 모양의 개별 칩으로 나누는 다이싱(Dicing) 작업을 진행하는데, 이러한 웨이퍼의 개별칩화를 싱귤레이션(Singulation)이라고 한다.
웨이퍼 판을 하나하나의 직육면체로 만들기 위해 톱질(Sawing)하는 것을 다이싱(Dicing) 또는 다이 소잉(Die Sawing)이라고 한다. 최근에는 반도체의 집적도가 높아짐에 따라 웨이퍼의 두께가 얇아지면서 싱귤레이션 종류가 점점 다양해지고 있다. 반도체 탐구 영역, 일곱 번째 시험 주제는 ‘싱귤레이션’이다. 웨이퍼를 반도체 칩으로 나누는 작업인 싱귤레이션에 대해 얼마나 알고 있는지 문제를 풀며 확인해 보자.
.jpg?width=1000&name=%EB%B0%98%EB%8F%84%EC%B2%B4%ED%83%90%EA%B5%AC%EC%98%81%EC%97%AD_(Singulation).jpg)
[정답] 아래를 드래그해 확인해 주세요!
▶ 1. ⑤ 2. ③ 3. ① 4. ⑤
[해설]
1. 스크라이브 다이싱(Scribe Dicing)은 웨이퍼를 브레이킹(Breaking) 하기 전에 웨이퍼 두께의 반 정도 깊이로 웨이퍼 표면을 블레이딩 한 뒤 브레이킹 하는 방식이다. 이 스크라이브 다이싱 이후 발전된 방식은 블레이드 다이싱. 블레이드 다이싱은 블레이드를 2~3번 연속으로 진행하는 방식이다. 레이저 다이싱은 높은 에너지를 가진 레이저를 웨이퍼의 스크라이브 라인에 주사해 실리콘을 파내는 방식으로 이루어진다. 또한 플라즈마 다이싱은 최근에 발전되고 있는 다이싱으로 팹(Fab) 공정의 플라즈마 식각을 이용한 방식이다. 한편 싱글 다이싱이라는 용어는 사용하지 않는다.
2. DBG는 기존 블레이딩 다이싱 방식의 문제점을 다이싱 순서를 변경함으로써 보완한 방식이다. 블레이드 다이싱은 블레이드를 2~3번 연속으로 진행하는 방식인데, 웨이퍼의 직경이 12인치로 늘어나고 두께가 매우 얇아지자 8인치 웨이퍼에서는 크게 문제가 되지 않았던 칩핑이나 크랙, 버가 문제되기 시작했다. 그에 따라 웨이퍼에 가해지는 물리적인 데미지(Damage)를 획기적으로 줄이기 위해 기존 다이싱의 표준 프로세스 대신 DBG 방식의 프로세스를 도입한다. 이는 블레이드 다이싱에서 진행했던 블레이딩을 2~3번 연속적으로 하지 않고, 1차 블레이딩을 실시한 후에 백그라인딩으로 웨이퍼 두께를 얇게 조절하면서 칩이 분리될 때까지 그라인딩을 계속하는 방식이다. 이는 기존 블레이드 다이싱 방식보다 진보된 것으로, 두 번째 블레이딩을 할 때 웨이퍼 절단면의 데미지를 줄이는 효과가 있어 웨이퍼 레벨 패키징에서 보편화돼 있다.
3. 레이저 스텔스 다이싱(Laser Stealth Dicing)은 웨이퍼 내부를 레이저 에너지로 먼저 절삭한 뒤 겉에 붙여둔 테이프에 외압을 가함으로써 표피를 끊어지게 해 칩을 분리하는 방식이다. 나머지 레이저 스크라이브, 레이저 블레이딩, 레이저 브레이크 다이싱 방식은 존재하지 않는다. 또한 레이저 표면 절삭 다이싱은 일반적인(Conventional) 레이저 다이싱을 말한다.
4. 처음에는 웨이퍼에서 트랜지스터 회로가 새겨진 다이(Die)를 분리해 내는 방법으로 외부 힘을 가하는 방식인 브레이킹만을 실시했다. 그러나 이런 방식은 웨이퍼로부터 분리되는 다이에 칩핑이나 크랙 등의 손상을 일으켰다. 뿐만 아니라 버가 충분히 제거되지 않아 절단면이 거칠어지는 문제점이 있었다. 그래서 사용된 방식이 스크라이브 다이싱(Scribe Dicing). 스크라이브 다이싱은 웨이퍼를 브레이킹 하기 전에 웨이퍼 두께의 반 정도 깊이로 웨이퍼 표면을 블레이딩 한 뒤 브레이킹 하는 방식이다. 스크라이브 다이싱은 이후 블레이드 다이싱으로 발전했다. 블레이드 다이싱은 블레이드를 2~3번 연속으로 진행한다. 또한 레이저 다이싱은 높은 에너지를 가진 레이저를 웨이퍼의 스크라이브 라인에 쬐어 실리콘을 파내는 방식으로 이루어진다. 플라즈마 다이싱은 최근 발전되고 있는 다이싱으로 팹(Fab) 공정의 플라즈마 식각을 이용한 방식이다.







